Na Figura-de-méritos do Baliga (BFOM) Aprimoramento de um novo transistor de efeito de campo vertical nanopilar GaN (FET) com canal 2DEG e Substrato padronizado
Resumo
Um novo transistor de efeito de campo vertical GaN (FET) de modo de realce com 2DEG para reduzir a resistência no estado ( R LIGADO ) e padrão de substrato (SP) para aumentar a tensão de ruptura (BV) é proposto neste trabalho. Ao projetar deliberadamente a largura e a altura do SP, o campo elétrico altamente concentrado (campo E) sob o limite de p-GaN poderia ser separado sem impactar drasticamente o R LIGADO , revelando uma Figura-de-méritos de Baliga aprimorada (BFOM, BV 2 / R LIGADO ) Verificado por simulação ATLAS calibrada experimentalmente, o dispositivo proposto com um SP de 700 nm de comprimento e 4,6 µm de largura apresenta BFOM seis vezes maior em comparação com o FET sem substrato padronizado. Além disso, o dispositivo pilar proposto e o SP interno ocupam apenas uma área de nanoescala, permitindo uma integração de alta densidade de tais dispositivos, o que torna seu alto potencial em futuras aplicações de energia.
Histórico
Hoje em dia, semicondutores de gap largo, como ZnO, In 2 O 3 , SiC e nitreto de gálio (GaN) têm chamado a atenção [1,2,3,4,5]. Considerando que, considerando as propriedades eletrônicas, o transistor lateral de alta mobilidade de elétrons AlGaN / GaN (HEMT) é amplamente considerado como um candidato potencial para substituir o dispositivo baseado em Si em aplicações de potência ou frequência devido à maior tensão de ruptura (BV), bem como a estabilidade térmica mais forte. Muitos esforços, como cap tipo p [6, 7], implantação de íon flúor [8, 9], barreira fina [10, 11], canal duplo [5, 12] e gate acoplado em campo [13] , foram feitas na realização do HEMT do tipo de melhoria que é desejado para simplificar o circuito do driver.
Essas tecnologias enfrentam, no entanto, muitos desafios formidáveis, como baixa uniformidade da tensão de limiar, o desperdício de área de chip vertical, colapso de corrente, Figura-de-méritos de Baliga (BFOM) limitada e assim por diante. Especialmente, a contradição entre o comprimento de deriva e o BV influencia negativamente a redução de escala do dispositivo [14, 15]. Em outras palavras, dispositivo menor leva a menor BV, em que é mais difícil adotar os terminais de junção que promovem o BFOM otimizando a distribuição do campo elétrico. Para este fim, barreira traseira [16], junção enterrada [17], placa de campo de poço quântico [18] e outras estruturas que são inseridas no HEMT lateral exibindo a característica da placa de campo elétrico foram propostas para aumentar BV utilizando a região vertical do chip.
Por outro lado, em virtude das naturezas superiores do GaN, o transistor de efeito de campo vertical de GaN (VFET) atrai cada vez mais atenção devido à realização mais fácil da funcionalidade do tipo realce e à plena utilização da região vertical [19 , 20,21,22]. Muitas novas estruturas são apresentadas por experimentos ou simulações para inclinar o BV e simultaneamente reduzir a resistência no estado ( R LIGADO ) [23,24,25]. No entanto, para não mencionar as dificuldades em fabricar a superjunção (SJ) em GaN, a falta do gás de elétron bidimensional de alta mobilidade (2DEG) leva a um R maior LIGADO [26], o que dificulta a otimização do BFOM em tais dispositivos.
Neste trabalho, um novo modo de aprimoramento vertical GaN FET com 2DEG para reduzir o R LIGADO e o padrão de substrato (SP) para aumentar o BV é proposto, em que a combinação do canal 2DEG e o SP equilibra efetivamente a contradição entre a baixa resistência no estado e o alto BV. Além disso, o pilar do dispositivo proposto e o SP em seu interior ocupam apenas uma área em nanoescala, possibilitando uma integração em alta densidade de tais dispositivos. Verificado por simulação numérica construída em ATLAS, o dispositivo proposto apresenta maior BFOM em comparação com o mesmo transistor de efeito de campo (FET) sem o substrato padronizado, tornando seu alto potencial em futuras aplicações de energia.
Método
O dispositivo proposto é gerado em um Al 0,23 normal Wafer de GaN / GaN com um substrato do tipo n altamente concentrado atuando como o eletrodo de drenagem, conforme mostrado na Fig. 1a, onde a espessura da camada de nitreto de silício (SiN), AlGaN e GaN são 105 nm, 20 nm e 5 μm , respectivamente. Um GaN tipo n com 2 × 10 16 cm −3 doping n D e um limite de GaN tipo p com 2 × 10 17 cm −3 doping n A é definido como o buffer e o canal composto, respectivamente [27, 28]. Outro componente do canal ao lado da porta é uma camada fina de AlGaN que é introduzida para induzir 2DEG como mostrado na Fig. 1b. A SP, feito de óxido de alumínio (Al 2 O 3 ), por exemplo, neste artigo, é cultivado no substrato.
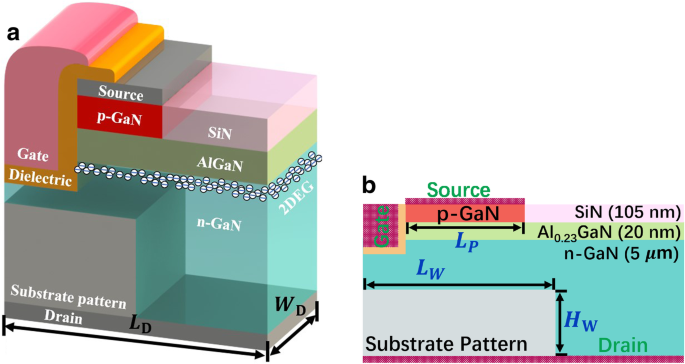
O esquema a Estrutura de pilares 3D e b seção transversal com parâmetros geométricos rotulados do SP-VFET proposto
Todo o dispositivo, portanto, pode ser fabricado por um processo padrão sucessivamente:(1) a deposição epitaxial do substrato de condução e a camada SP integrada, (2) o ataque parcial do padrão SP, (3) a deposição e polimento de n- Buffer GaN, (4) a deposição da barreira AlGaN e tampa p-GaN, e (5) a fabricação de eletrodos e passivação.
O simulador ATLAS implantado é calibrado pelos dados experimentais de um HEMT do tipo realce com um cap p-GaN [29, 30]. As especificações calibradas e outras especificações do dispositivo são mostradas na Tabela 1. Outras configurações podem ser encontradas em nosso trabalho anterior [31]. O tipo e a densidade do trap de interface localizado na interface SP / GaN são referidos como medições experimentais baseadas na capacitância [32,33,34]. A carga de polarização na superfície AlGaN / GaN é confirmada de acordo com a equação de ajuste quadrático simples correspondente [35].
Mecanismo de física
No estado ligado, em comparação com o dispositivo sem o canal 2-DEG e o SP, o transistor de efeito de campo vertical proposto com padrão de substrato (SP-VFET) apresenta um caminho altamente condutor devido ao 2-DEG e um canal de corrente vertical mais estreito que encolhe a condutância como mostrado na Fig. 2. Em detalhes, graças ao 2DEG de alta densidade concentrado na interface AlGaN / GaN, o caminho lateral do fluxo de corrente pode ser sustentado, o que compensa parcialmente a condutância do dispositivo inteiro. Em contraste, a capacidade de transporte atual do dispositivo SP-VFET sem canal 2DEG seria influenciada dramaticamente.
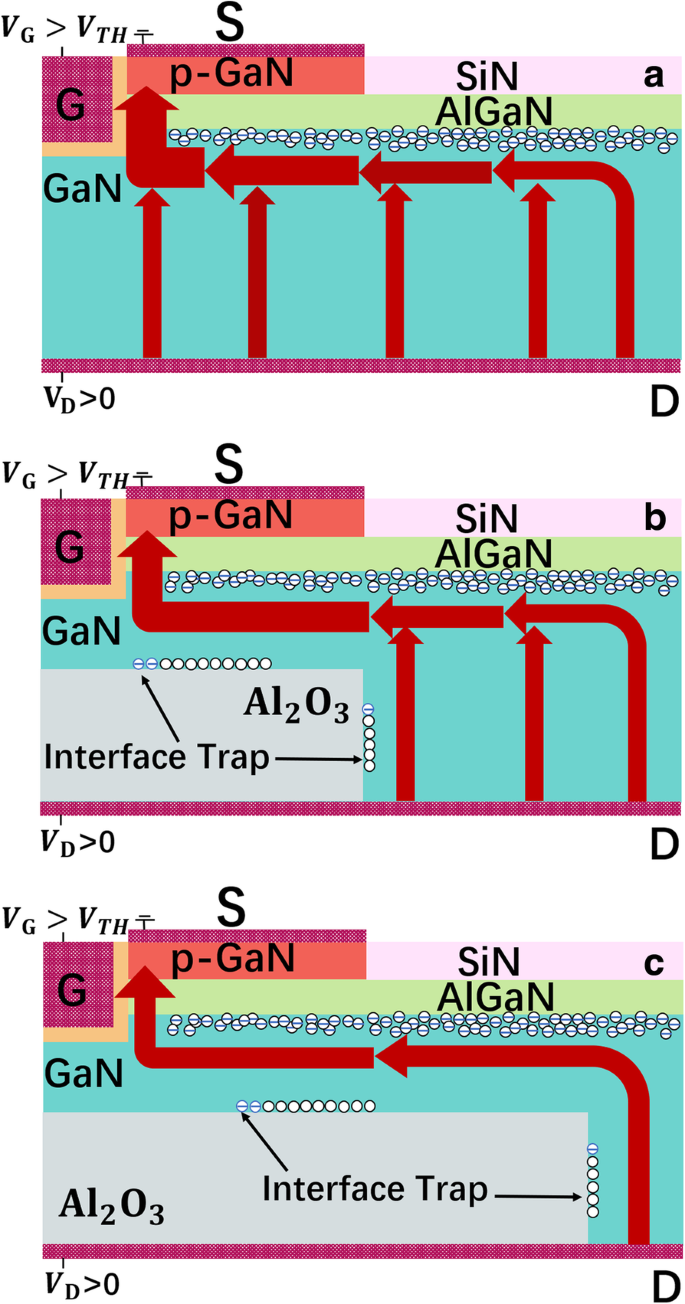
A ilustração esquemática do fluxo da corrente direta em a o dispositivo sem o SP, b o SP-VFET proposto com um SP curto, e c um longo SP
O comprimento do limite p-GaN não influenciaria dramaticamente a concentração do campo elétrico (campo E) até que o comprimento seja superior a 700 nm, pelo qual o p-GaN quase cobre toda a superfície do dispositivo. Conforme mostrado na Fig. 3, a distribuição do campo E ao longo da interface AlGaN / GaN possui um pico em torno do canto direito do p-GaN. A posição do pico muda junto com o comprimento variável de p-GaN e, no entanto, mantém a mesma magnitude. Uma pequena diferença do valor de pico pode ser vista na Fig. 3 quando o limite de p-GaN é maior do que 600 nm, porque o limite de p-GaN longo aplaina todo o campo E no dispositivo e, por meio disso, expande a resistência do dispositivo devido ao esgotamento do 2DEG.
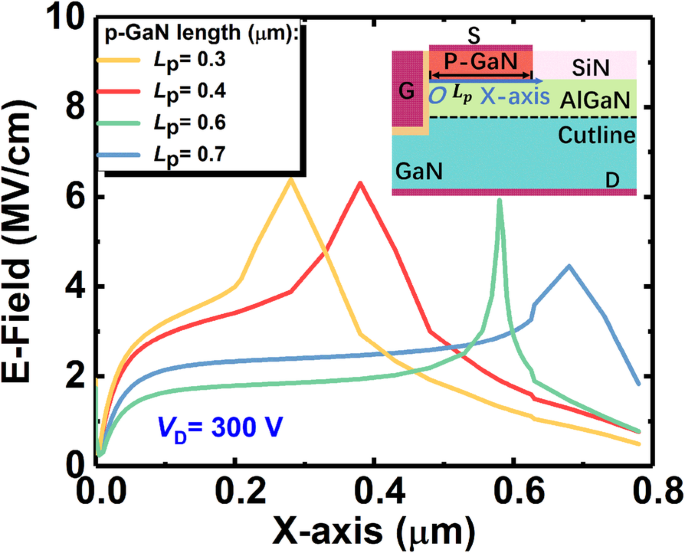
A distribuição do campo elétrico do dispositivo sem o SP ao longo da heterojunção AlGaN / GaN em diferentes comprimentos de p-GaN
Para ilustrar a influência do p-GaN, 2-DEG e do SP introduzidos simultaneamente, um modelo de condução no estado pode ser construído, conforme esquematicamente mostrado na Fig. 4a. M 1 e M 2 são os transistores do tipo MIS com o canal de condução formado em p-GaN e AlGaN respectivamente. R 1 representa a parte infinitesimal da resistência vertical em GaN em massa. R 2 e R 3 representam as partes de resistência infinitesimais do canal de 2 DEG com e sem estar parcialmente esgotado, respectivamente. De acordo com a lei de resistência, R 1 , R 2 , e R 3 pode ser obtido como
$$ {R} _1 =\ frac {1} {n_1 q \ mu} \ bullet \ frac {l} {dx \ bullet {W} _D} $$$$ {R} _2 =\ frac {1} {n_2 q \ mu} \ bullet \ frac {dx} {t \ bullet {W} _D} $$$$ {R} _3 =\ frac {1} {n_3 q \ mu} \ bullet \ frac {dx} {t \ marcador {W} _D} $$
onde n 1 , n 2 e n 3 representam a concentração elétrica em GaN, não esgotado 2-DEG e esgotado 2-DEG, respectivamente; q é a carga do elétron e μ é a mobilidade do elétron em GaN; l é o comprimento do caminho condutor vertical e dx é o comprimento infinitesimal no horizonte; W D é a largura do dispositivo; e t é a espessura do 2-DEG. Por conveniência, t é definido como 10 nm [7]. A concentração do empobrecido 2-DEG sob p-GaN n 3 é igual à concentração não esgotada n 1 menos a carga negativa total no p-GaN empobrecido [31], que lê
$$ {n} _3 ={n} _2- {n} _A {x} _D $$
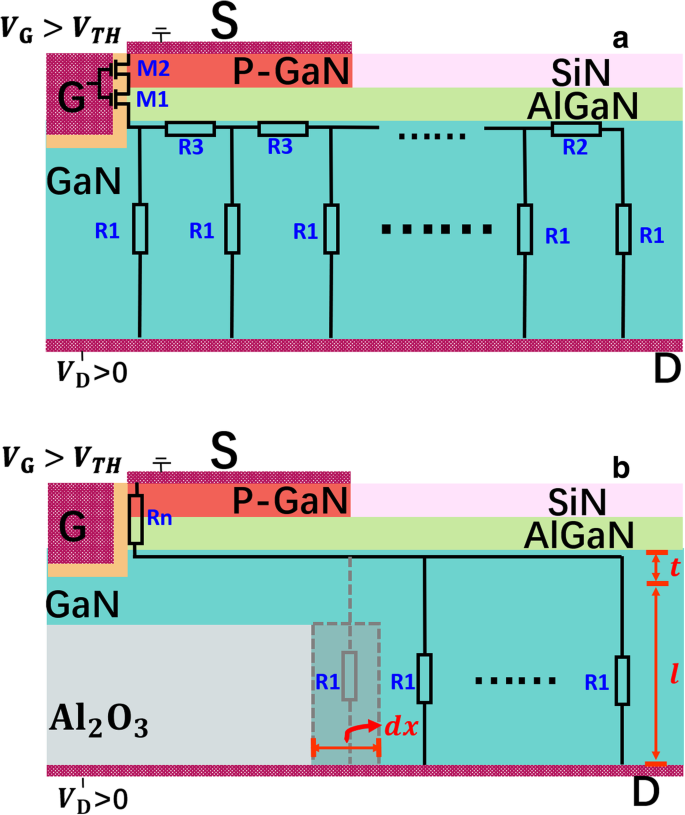
O esquema de a modelo no estado proposto sem SP b modelo de rede de resistência no estado com SP
O limite p-GaN pode ser considerado totalmente esgotado, portanto, x D é igual a 105 nm, a espessura de p-GaN. Comparado com R 1 , R 2 e R 3 são muito mais baixos do que R 1 , por causa de sua maior concentração de elétrons e caminho condutor mais curto. Portanto, a resistência no canal 2-DEG pode ser ignorada. Além disso, quando a tensão de dreno é pequena e os transistores do tipo MIS M 1 e M 2 trabalhar no modelo insaturado, a resistência no estado de M 1 e M 2 pode ser considerada como uma resistência constante ignorável R n . Para simplificar o cálculo, a forma analítica da condutância do caminho da corrente vertical G v do caminho da corrente vertical pode ser obtido como
$$ {G} _v ={\ int} _0 ^ {L_D} \ frac {1} {R_1} ={\ int} _0 ^ {L_D} {n} _1 q \ mu \ bullet \ frac {dx \ bullet { W} _D} {l} $$
onde L D é o comprimento do dispositivo.
Portanto, a resistência interna R em pode ser obtido, que lê
$$ {R} _ {on} =\ frac {1} {G_v} + {R} _n =\ frac {1} {n_1 q \ mu} \ bullet \ frac {l} {L_D \ bullet {W} _D } + {R} _n $$
Quando existe SP, como mostrado na Fig. 4b, o caminho condutor vertical foi bloqueado parcialmente. Assim, a condutância do caminho da corrente vertical pode ser expressa como
$$ {G} _v ={\ int} _ {L_W} ^ {L _ {\ mathrm {D}}} \ frac {1} {R_1} ={\ int} _ {L_W} ^ {L_D} {n} _1 q \ mu \ bullet \ frac {dx \ bullet {W} _D} {l} $$
onde L W é o comprimento do SP.
Portanto, o R correspondente em pode ser expresso como
$$ {R} _ {on} =\ frac {1} {G_v} + {R} _n =\ frac {1} {n_1 q \ mu} \ bullet \ frac {l} {\ left ({L} _D - {L} _W \ right) \ bullet {W} _D} + {R} _n $$
No estado desligado, devido à funcionalidade semelhante a um capacitor e à armadilha de interface carregada negativamente, o SP redistribuiria o campo elétrico sob a tampa p-GaN de forma eficaz, resultando em uma concentração de campo em torno do SP que possui um gap de banda mais amplo, conforme mostrado em Fig. 5. Essa redistribuição de campo E encolhe a região de depleção que aparece em torno de p-GaN e a porta e, assim, alivia a alta concentração de campo em torno da tampa de p-GaN e da porta, o que aumentaria o BV do VFET SP notavelmente. Por outro lado, como mencionado acima, o SP influenciaria a condutância do dispositivo de tal forma que a carga negativa introduzida pelo SP leva ao aumento da energia potencial próximo à porta, o que explica a diminuição de 2-DEG próximo à porta. Como resultado, um BFOM flutuante seria obtido com a variação do comprimento e da altura do SP.
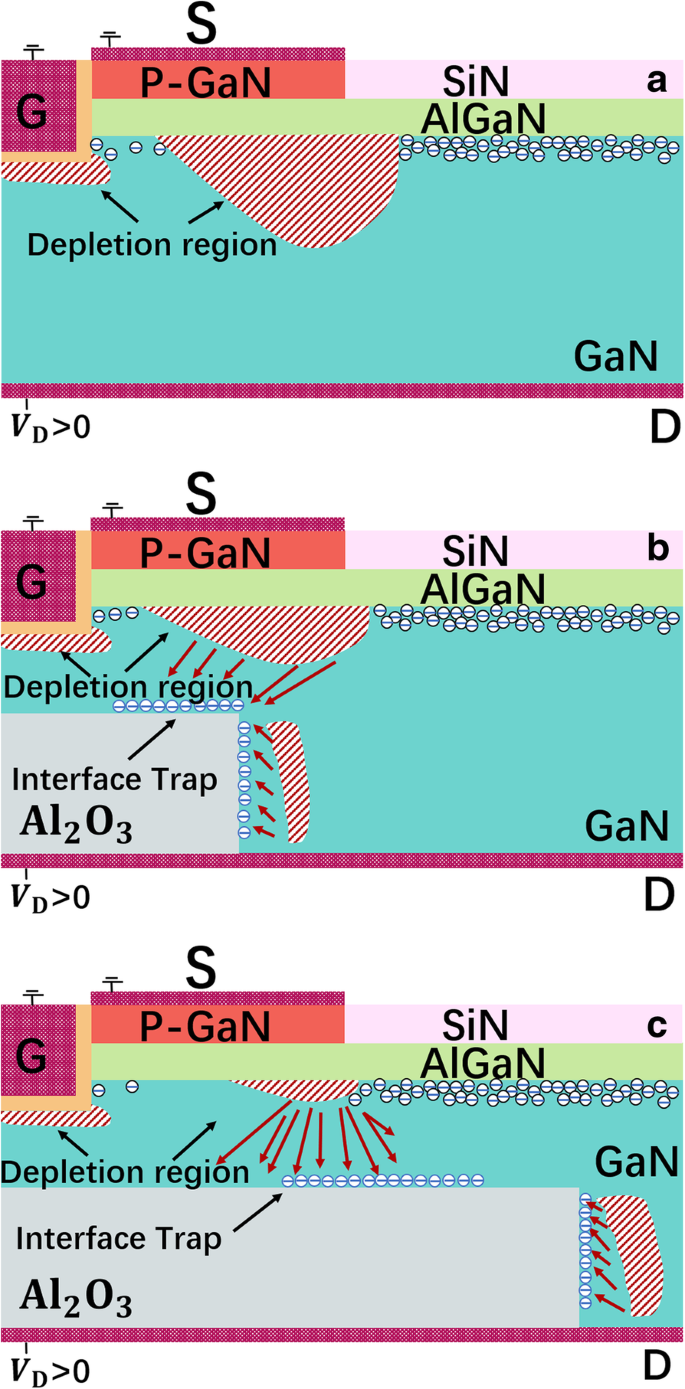
A distribuição esquemática do campo elétrico e região de esgotamento em a o dispositivo sem o SP, b o SP-VFET proposto com um SP curto, e c o SP-VFET proposto com um SP longo
Em outras palavras, o SP poderia reduzir o pico do campo E em torno do canto do p-GaN e, simultaneamente, atrair o campo E concentrando-se no SP, como mostrado na Fig. 6a, b. No entanto, graças ao campo E crítico mais alto do SP, tal concentração de campo E não quebraria o dispositivo, pelo qual o VFET SP exibiria muito mais alto BV.
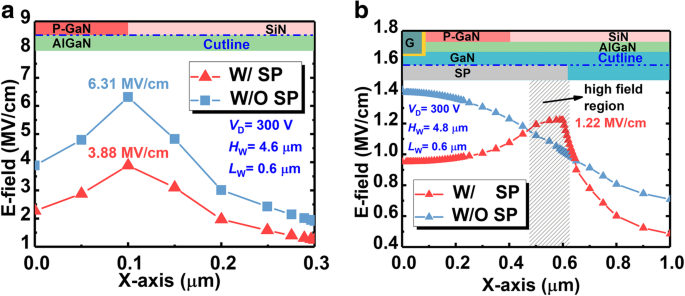
A distribuição do campo elétrico do SP-VFET proposto ao longo da interface de a p-GaN / AlGaN e b GaN / SP
Resultado e discussão
A Figura 7a, b mostra respectivamente as curvas de transferência e saída do dispositivo proposto sem o SP. Com diferentes comprimentos do cap p-GaN, essas curvas se sobrepõem em ambos os regimes subliminar e de ativação, sugerindo que o comprimento do cap p-GaN não influencia a condutância do dispositivo sem o SP. Em outras palavras, embora o limite de p-GaN esvazie parcialmente o 2-DEG e, por meio disso, afete a resistência do canal de 2-DEG, o 2-DEG remanescente ainda possui uma grande concentração n 3 que se aproxima da concentração não esgotada n 2 , que é realizado otimizando a concentração do tipo p no cap de p-GaN. Além disso, conforme analisado antes, a resistência do canal de 2 DEG é bastante pequena em comparação com a resistência do n-GaN no caminho vertical. Portanto, as curvas de transferência se sobrepõem na Fig. 7a, b. No entanto, para proteger o portão do campo E altamente concentrado, tal aglomeração não deve ser adjacente ao portão, o que significa que o comprimento do p-GaN não pode ser muito curto. Assim, o comprimento mínimo do p-GaN em nosso trabalho é 400 nm, a menos que indicado de outra forma.
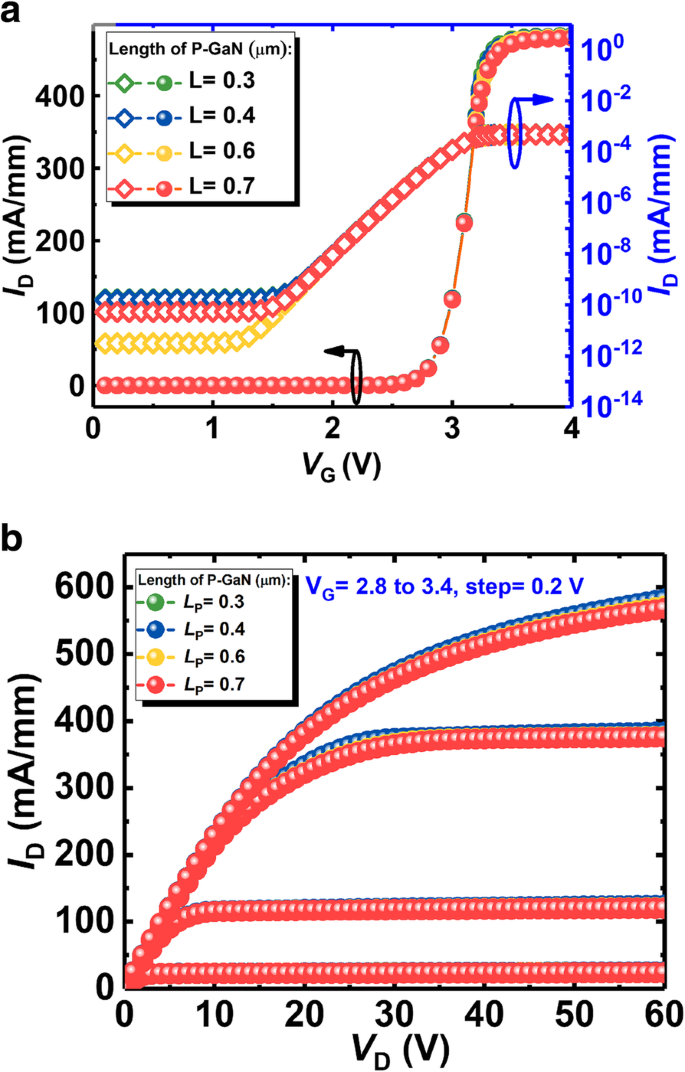
a As curvas de transferência e b curvas de saída do dispositivo sem o SP em comprimento diferente do limite p-GaN
A Figura 8 mostra as características de saída do SP-VFET proposto e do VFET sem o SP. Pode-se observar que o SP impõe a resistência do dispositivo ao estreitar o canal de condução vertical. Em detalhe, a resistência no estado ligado é independente da altura do SP quando a altura está abaixo de 4,7 μm, enquanto, depende significativamente do comprimento do SP que corresponde ao mecanismo de que o caminho de corrente vertical estreito reduz a condutância. A primeira independência ocorre porque o 2DEG é o principal canal de condução lateral que não seria enfraquecido pelo SP em sua altura moderada. No entanto, se o SP estiver adjacente ao canal de 2 DEG, a carga negativa introduzida em torno do SP irá nivelar a banda de energia, resultando na diminuição dramática da concentração de 2 DEG. Consequentemente, a resistência do 2-DEG aumenta e a resistência total no estado R em aumenta em conformidade. Além disso, a dependência posterior vem da resistência notavelmente aumentada no canal vertical como mencionado acima. Além disso, deve-se notar que os defeitos da rede em 2-DEG induzidos por alto SP limitam a altura do SP.
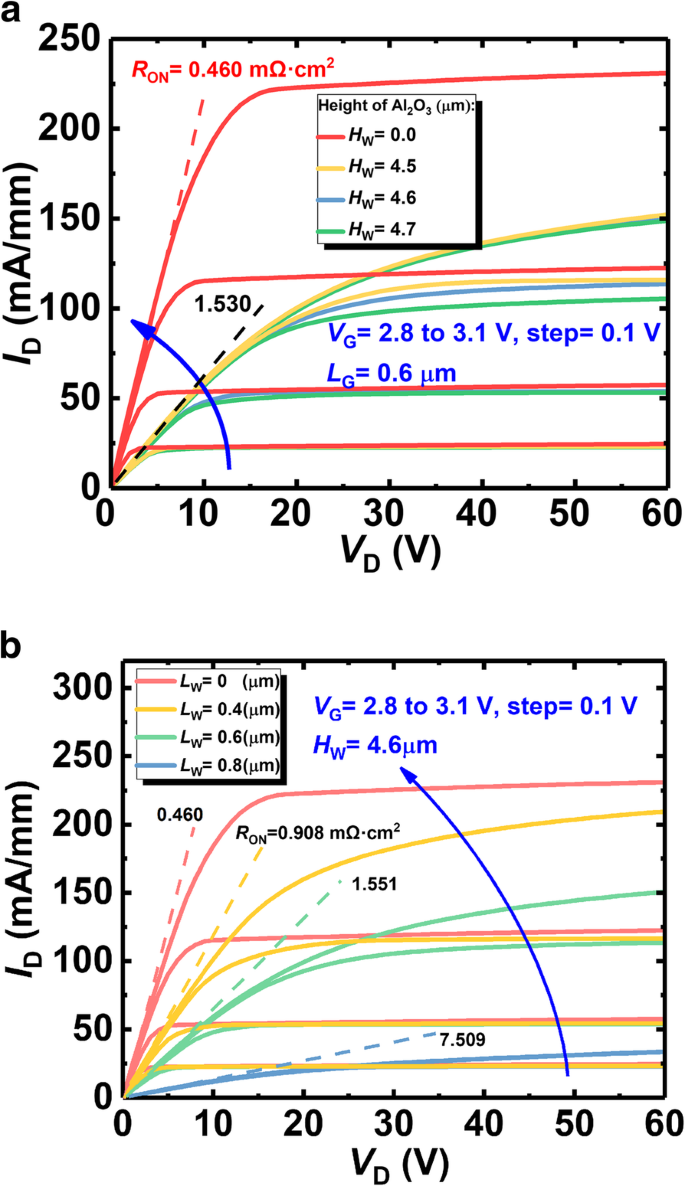
As curvas de saída do SP-VFET proposto com variação de a Largura SP e b Comprimento do SP em comparação com o dispositivo sem SP
A Figura 9 mostra os detalhes da distribuição da densidade de corrente ao redor da porta dos dispositivos VFET com ou sem SP, em que o VFET sem SP tem uma capacidade de transporte de corrente mais alta que está em linha com a Fig. 8a. E, ao contrário, o SP-VFET reduz a condução da corrente ao estreitar o canal vertical. Enquanto isso, as figuras detalhadas ilustram claramente que a corrente no canal lateral é transportada pelo 2DEG, e a densidade de corrente total muda ligeiramente com o aumento da altura do SP, o que também é demonstrado na seção do mecanismo. Os resultados indicam que a resistência do canal lateral não é imposta notavelmente pelo SP dentro de uma altura moderada.
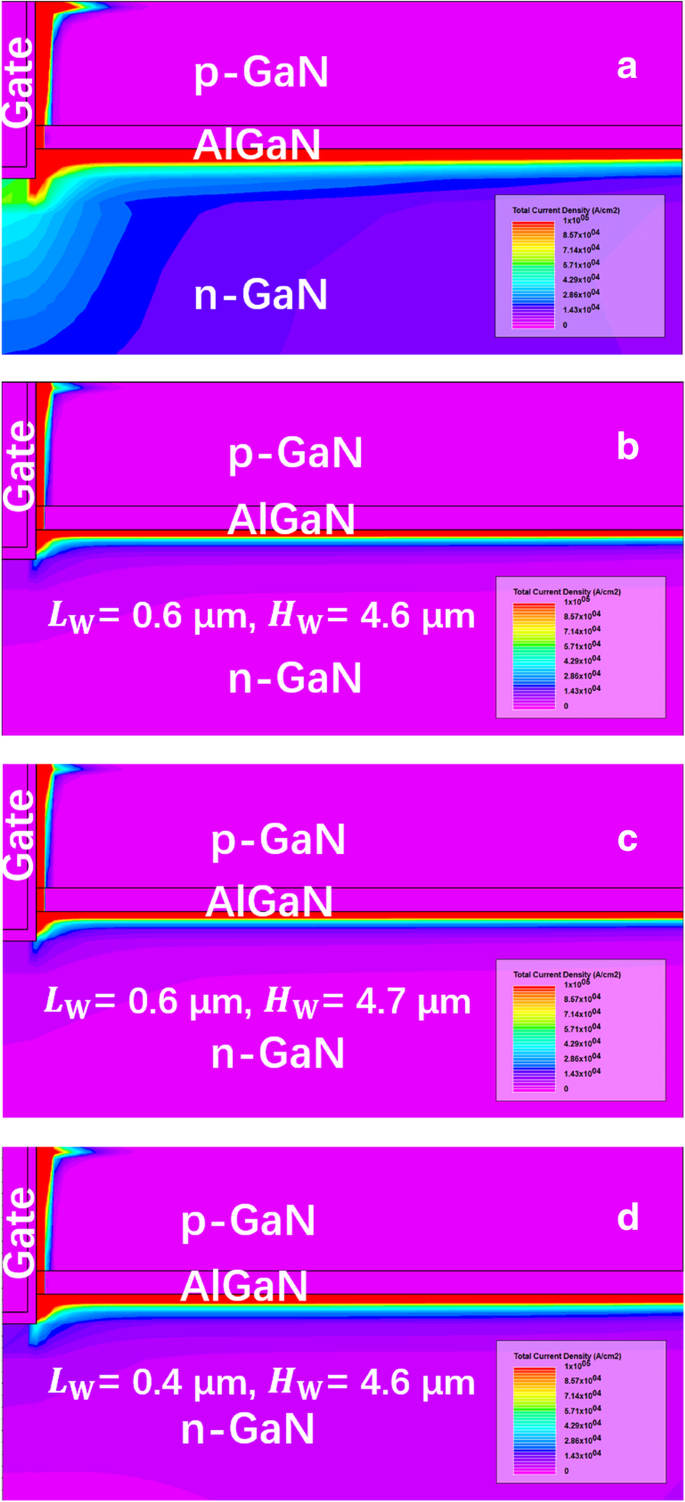
A densidade atual de a o dispositivo sem o SP e b - d o SP-VFET proposto com diferentes parâmetros geométricos de SP
A Figura 10a mostra a resistência no estado extraída e o BV correspondente. A resistência do SP-VFET aumenta com SP mais longo. E, especialmente, a curva da resistência versus comprimento de SP exibe uma tendência hiperbólica, e o gradiente da curva aumenta com o comprimento de SP mais longo. Conforme analisado antes, R em varia com diferentes comprimentos de SP L W em uma forma de função hiperbólica, que corresponde ao resultado da simulação. Além disso, a curva da resistência com diferentes alturas de SP se sobrepõe à medida que a altura é inferior a 4,7 μm, sugerindo que o canal 2-DEG é o principal caminho condutor lateral e o canal 2-DEG não é afetado, como mencionado acima.
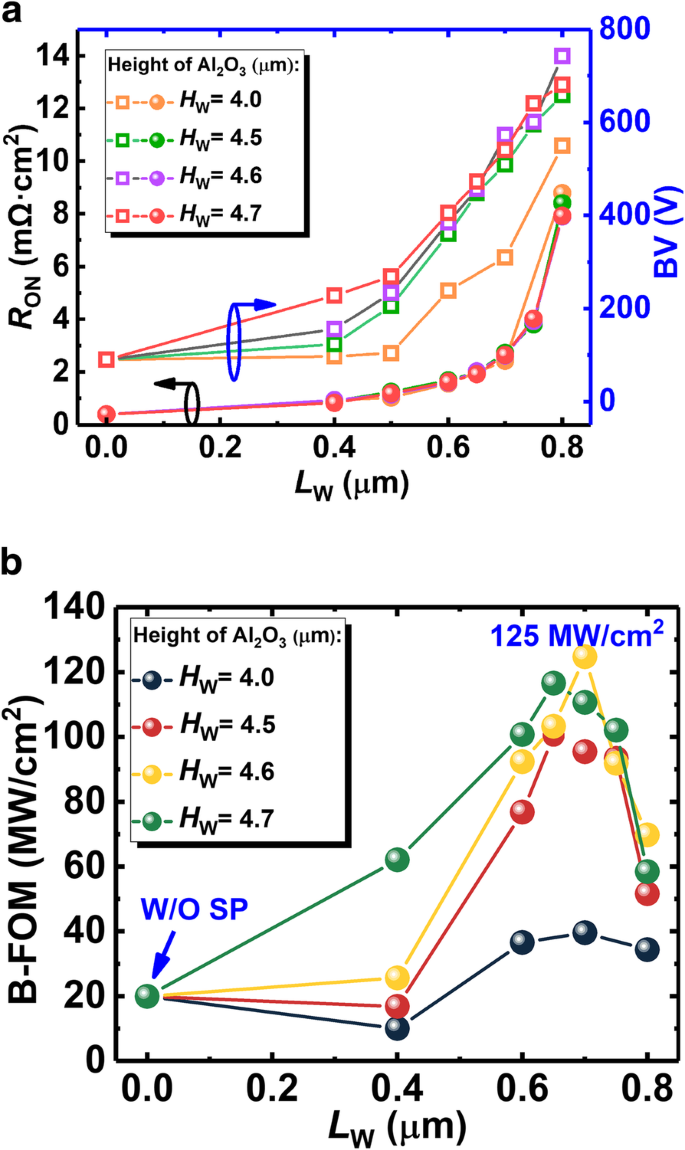
a A resistência no estado extraída, bem como BV, e b o BFOM de acordo com o SP-VFET proposto em diferentes comprimentos e larguras de SP
A Figura 10b mostra o BFOM calculado do SP-VFET. Devido à taxa de aumento diferente de BV e resistência no estado, o BFOM de todos os dispositivos primeiro cresce e depois cai após o comprimento do SP maior que 400 nm. Um pico de BFOM de 125 MW / cm 2 é alcançado quando o comprimento atinge 700 nm e a altura atinge 4,6 μm. Comparado com o dispositivo sem o SP, o SP-VFET proposto tem um desempenho mais de seis vezes melhor em termos de BFOM.
Esta melhoria é alcançada devido à supressão do alto campo E sob o p-GaN, graças à interceptação de interface carregada negativamente em torno do SP. A interação, que ocorre entre a carga negativa capturada na interface do SP e a região de depleção em torno do p-GaN, forma uma nova distribuição do campo E principalmente em direção à carga capturada. De acordo com a lei de Gauss, o fluxo elétrico é limitado pela carga circundada. Assim, o campo E introduzido afetará o fluxo elétrico em direção a outro lugar. Como a carga negativa da região de depleção é a principal fonte para o campo E lotado em torno de p-GaN, o campo E introduzido pela carga aprisionada terá um papel na supressão do campo E lotado em torno de p-GaN e, consequentemente, BV é aprimorado. Especificamente, quando o comprimento de SP é inferior a 400 nm, a carga negativa introduzida por SP está longe da região de depleção. Assim, o campo E formado entre a região de depleção e a carga negativa aprisionada é muito pequeno para desempenhar um papel em afetar o campo E lotado sob p-GaN. E, como resultado, o BV do dispositivo cresce ligeiramente. No entanto, como o comprimento de SP é superior a 400 nm, devido à carga negativa mais aprisionada na interface do SP e à distância mais curta entre a região de depleção e a carga negativa presa, o campo E entre a região de depleção e a carga negativa presa é reforçada, levando ao crescimento do BV.
Além disso, a região ao redor do SP está tremendamente esgotada devido à carga negativa introduzida por SP. E como mostrado na Fig. 11, com o SP mais longo, o caminho da corrente de fuga vertical se restringe em largura devido à região esgotada comprimindo para a borda do dispositivo, que também bloqueia a corrente de fuga e, consequentemente, aumenta o BV. Portanto, o BV aumenta notavelmente com o aumento do comprimento de SP.
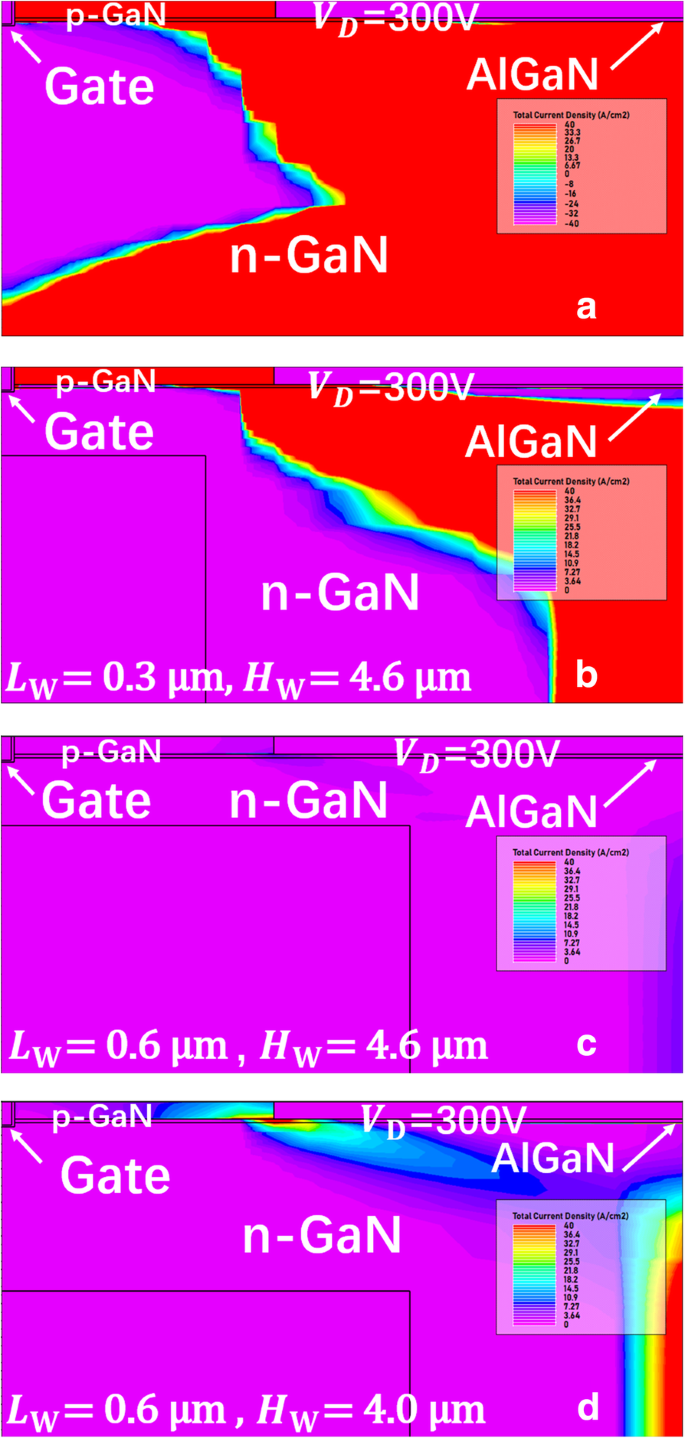
A densidade de corrente de fuga de a o dispositivo sem o SP e b - d o SP-VFET proposto com diferentes parâmetros geométricos de SP
A Figura 12 mostra a distribuição do campo E simulado no SP-VFET quando a tensão de dreno é 300 V, onde aparentemente o SP induz outros novos pontos de concentração do campo E, o que significa que a região do campo E do pico sob o p-GaN é suprimida . Em comparação com a distribuição do campo E nos dispositivos com diferentes alturas de SP, o aumento do comprimento de SP suprime a concentração do campo E e, consequentemente, aumenta o BV de forma mais eficiente.

A distribuição do campo E em torno do portão do VFET a com ou b - d sem o SP quando a tensão de dreno é 300 V
Esse campo E achatado também pode ser observado explicitamente na Fig. 13, na qual as distribuições do campo E ao longo da borda horizontal e perpendicular do SP (veja a linha de corte) são plotadas. Como demonstrado na Fig. 12 policromada, pode ser visto na Fig. 13 que SP mais alto e mais longo desempenha um papel cada vez mais eficaz na reconstrução do campo E sob p-GaN e, atraindo campo E para se concentrar em todo o SP Beira. Essa redistribuição neutraliza o campo E em torno do p-GaN vulnerável. Assim, o BV do dispositivo é aprimorado, aumentando o B-FOM do SP-VFET proposto.
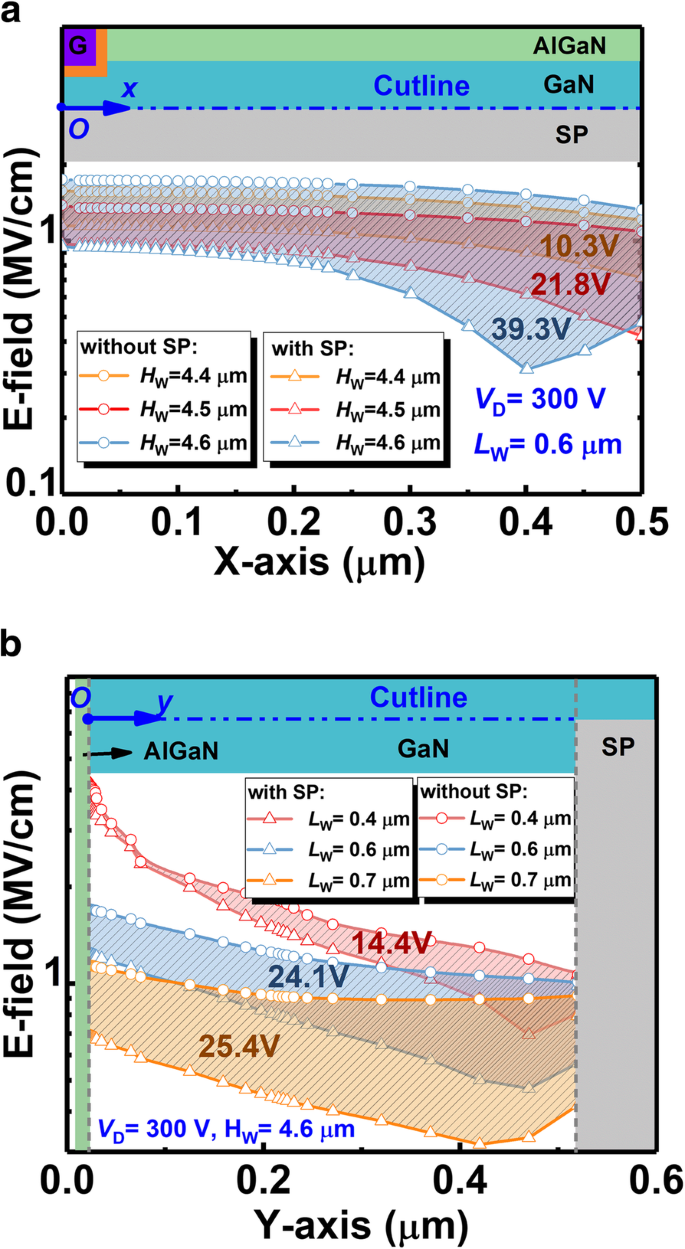
A distribuição do campo E a horizontalmente e b extraído perpendicularmente ao longo da linha de corte da borda SP no SP-VFET
Conclusão
Neste trabalho, um novo FET vertical GaN tipo realce (SP-VFET) com canal 2DEG e padrão de substrato para melhorar o BFOM do mesmo é proposto e investigado. Verificado por simulação calibrada experimentalmente implementada com ATLAS, é o SP que alivia o pico do campo E sob o p-GaN e, simultaneamente, atrai nova concentração de campo E através do SP que possui campo E crítico superior. Consequentemente, o BV do SP-VFET proposto é aumentado com uma resistência no estado moderadamente crescente devido à compensação 2DEG. O BFOM do SP-VFET, portanto, é aprimorado seis vezes melhor do que o do dispositivo sem o SP quando o comprimento e a altura do SP são 700 nm e 4,6 μm, respectivamente, tornando o potencial promissor do SP-VFET proposto em potência de alta densidade integração.
Abreviações
- n A :
-
Concentração de dopagem de GaN tipo p
- n D :
-
Concentração de dopagem de GaN tipo n
- 2DEG:
-
Gás de elétron bidimensional
- Al 0,23 GaN:
-
Nitreto de gálio e alumínio com uma fração molar de 0,23 para o alumínio
- Al 2 O 3 :
-
Óxido de aluminio
- BFOM:
-
Figura de mérito de Baliga
- D SP :
-
Densidade de interceptação de interface do padrão de substrato
- E-field:
-
Campo elétrico
- E T :
-
A diferença entre a banda de condução e o nível de energia da armadilha de interface
- FET:
-
Transistor de efeito de campo
- GaN:
-
Nitreto de gálio
- HEMT:
-
Transistor de alta mobilidade de elétrons
- H G :
-
Altura do portão
- H W :
-
Altura do padrão do substrato
- L D :
-
Comprimento do dispositivo
- L G :
-
Comprimento do portão
- L P :
-
Comprimento do cap p-GaN
- L W :
-
Comprimento do padrão do substrato
- SiN:
-
Nitreto de silício
- SP:
-
Padrão de substrato
- SP-VFET:
-
Transistor de efeito de campo vertical com padrão de substrato
- W D :
-
Profundidade do dispositivo
- σ p :
-
Carga de polarização
Nanomateriais
- Na estrada com IoT
- Impacto dos estados da superfície e da fração da toupeira de alumínio no potencial da superfície e 2DEG em HEMTs AlGaN / GaN
- Modulação das propriedades de anisotropia eletrônica e óptica de ML-GaS por campo elétrico vertical
- O efeito do plasma sem equilíbrio de contato nas propriedades estruturais e magnéticas de Mn Х Fe3 - X О4 Spinels
- Efeito do tratamento de recozimento in situ na mobilidade e morfologia de transistores de efeito de campo orgânico baseados em TIPS-Pentaceno
- Síntese controlada de BaYF5:Er3 +, Yb3 + com morfologia diferente para o aprimoramento da luminescência de conversão ascendente
- Efeitos de fotocondutividade, sensibilidade de pH, ruído e comprimento do canal em sensores FET de nanofios de Si
- Síntese Verde de Nanopartículas de Metal e Óxido de Metal e Seu Efeito na Alga Unicelular Chlamydomonas reinhardtii
- Efeito da morfologia e estrutura cristalina na condutividade térmica dos nanotubos de Titânia
- Preparação de um arranjo de nanosfera de poliestireno periódico usando o método Dip-Drop com ataque pós-deposição e sua aplicação para melhorar a eficiência de extração de luz de InGaN / G…



