Medições locais de VOC por microscopia de força de sonda Kelvin aplicada em nanofios de Si de junção radial P-I-N
Resumo
Este trabalho enfoca a extração da tensão de circuito aberto ( V OC ) em nanofios fotovoltaicos por fotovoltagem de superfície (SPV) com base em medições de microscopia de força de sonda Kelvin (KPFM). Em uma primeira abordagem, dispositivos de nanofio de silício (SiNW) de junção radial P-I-N (RJ) foram investigados sob iluminação por KPFM e análise de corrente-tensão (I-V). Dentro de 5%, o SPV extraído se correlaciona bem com o V OC . Em uma segunda abordagem, as medições locais de SPV foram aplicadas em SiNWs de junção radial isolada única apontando os efeitos de sombreamento da ponta de AFM que podem impactar fortemente a avaliação de SPV. Várias estratégias em termos de formato da ponta de AFM e orientação de iluminação foram implementadas para minimizar este efeito. As medições locais de SPV em SiNWs de junção radial isolada aumentam logaritmicamente com a potência de iluminação e demonstram um comportamento linear com o V OC . Os resultados mostram notavelmente que as medições sem contato do V OC tornam-se viáveis na escala de dispositivos SiNW fotovoltaicos individuais.
Introdução
As nanoestruturas de semicondutor atraem um grande interesse de pesquisa por causa de suas propriedades em nanoescala, que oferecem um grande potencial para melhorar o desempenho em dispositivos existentes. Matrizes de nanofios baseados em junções radiais (RJs) são nanoestruturas promissoras para aplicações fotovoltaicas (PV) devido às suas propriedades de captura de luz e coleta de portadores [1, 2] que são combinadas propositalmente para aumentar a eficiência solar em relação às estruturas planas convencionais. A eficiência das células solares de nanofios pode ser limitada por junções de nanofios danificadas na matriz; no entanto, eficiências de até 9,6% já foram demonstradas para nanofios de silício (SiNW) RJs com base na tecnologia de película fina de Si [3]. A caracterização de tais estruturas permanece uma questão crítica, e notavelmente a possibilidade de caracterizar o desempenho fotoelétrico de nanofios individuais é um valor agregado para o aprimoramento do dispositivo final.
No presente estudo, usamos a microscopia de força de sonda Kelvin (KPFM) para avaliar a tensão de circuito aberto local ( V OC ) em SiNW RJs. A análise de V OC foi avaliado com sucesso pelo KPFM em vários tipos de tecnologias fotovoltaicas, principalmente estruturas planas [3, 4]. No entanto, a análise KPFM em nanodispositivos PV não é direta, notadamente devido ao fato de que pode exigir a realização de medições em condições de escuridão e iluminação para extrair a variação do potencial de superfície, denominada fotovoltagem de superfície (SPV).
Nossa primeira abordagem para sondar o V local OC de RJ SiNWs foi analisar dispositivos concluídos. O termo concluído refere-se às células solares RJ SiNW que são finalizadas com ITO como eletrodo frontal. Os seguintes dispositivos concluídos foram sequencialmente caracterizados por medições de corrente-tensão (I-V) e KPFM. Ambas as medições foram realizadas sob condições de escuridão e iluminação com o objetivo final de extrair e comparar V OC e SPV. Nossa segunda abordagem foi analisar SiNWs isolados de RJ que não foram revestidos por ITO. Nosso objetivo particular foi otimizar o sinal KPFM sob iluminação, evitando muitos artefatos que podem resultar na subestimação do valor de SPV. Cada RJ SiNW isolado será referido como dispositivo isolado.
Finalmente, para completar os resultados, a técnica macroscópica da sonda Kelvin também foi aplicada em um dispositivo RJ completo e em vários dispositivos isolados. Isso foi feito sob iluminação em diferentes comprimentos de onda, a fim de realizar a espectroscopia de fotovoltagem de superfície (SPS).
Materiais e métodos
Crescimento de SiNW e fabricação de dispositivo de junção P-I-N radial
Os RJ SiNWs foram preparados em um substrato de vidro Corning revestido com ZnO:Al (Cg). O crescimento de SiNWs foi feito a uma temperatura de substrato de 500 ° C por Plasma Enhanced Chemical Vapor Deposition (PECVD) e foi mediado usando nanopartículas de Sn como catalisadores. O P-I-N RJ foi obtido depositando finas camadas conformadas de Si amorfo hidrogenado intrínseco (80 nm) e então tipo n (10 nm) (a-Si:H) também por PECVD a 175 ° C no núcleo de SiNW tipo p. Os dispositivos concluídos foram finalizados com uma deposição conformada de ITO formando contatos superiores circulares de 4 mm de diâmetro definidos por uma máscara durante a deposição por pulverização catódica. Os detalhes completos da fabricação são explicados em outro lugar [1, 5,6,7].
Kelvin-Probe e superfície fotovoltagem
As medições KPFM podem ser realizadas usando dois modos diferentes, modulação de amplitude (AM) e modulação de frequência (FM). Ambos os modos permitem obter o mesmo valor de propriedade da diferença de potencial de contato (CPD) existente entre a ponta e a superfície da amostra. O modo AM foi o escolhido neste estudo, devido à sua maior estabilidade de medição na presença de variações significativas de altura, como as observadas na borda dos nanofios da amostra.
As medições de KPFM e SPV foram realizadas usando um sistema de microscopia por sonda de varredura da HORIBA / AIST-NT (plataforma TRIOS) que oferece várias vantagens. De fato, para este microscópio de força atômica (AFM), o sistema de deflexão baseado em feixe de laser (LBBDS) emprega um comprimento de onda de laser em 1310 nm que minimiza as possíveis interações fotoelétricas com a amostra [8,9,10 ] . Isso será enfatizado aqui, comparando os dados adquiridos usando esta plataforma com os obtidos usando um sistema AFM que usa um comprimento de onda de 690 nm para o LBBDS.
A plataforma TRIOS é adequada para estudar propriedades fotoelétricas de materiais, pois inclui três objetivas de microscópio que permitem a iluminação da amostra de diferentes direções (superior, lateral e inferior). As medições de SPV na escala micro / nano são obtidas subtraindo o CPD no escuro ao CPD sob iluminação. Este tipo de medição foi usado anteriormente para realizar V OC medições de dispositivos fotovoltaicos [5, 11]. A iluminação da amostra foi realizada utilizando um diodo laser estabilizado OXXIUS de comprimento de onda 488 nm com um módulo de potência variável.
Dois tipos de pontas de AFM condutivas foram usadas para as medições de ponta de prova de varredura aplicadas, a ARROW-EFM e a ATEC-EFM. Ambos têm um cantilever de silício dopado e um revestimento PtIr. A diferença está em sua forma com uma forma de ponta convencional para a SETA e uma forma inclinada para o ATEC.
Finalmente, as medições de SPV em nanoescala foram complementadas com medições macroscópicas de Kelvin Probe com a possibilidade de variar o comprimento de onda de iluminação para realizar medições de SPS, ou seja, medições de SPV espectralmente resolvidas. Para este propósito, foi usada uma configuração de sonda Kelvin ASKP200250 da KPTechnology equipada com uma ponta de aço de 2 mm de diâmetro. Esta configuração inclui uma iluminação do lado acoplando uma fonte de lâmpada de halogênio a um monocromador que cobre a faixa de comprimento de onda de 400 nm a 1000 nm. Observe que esta configuração não permite realizar medições de SPV em fluxo constante e, por esta razão em particular, apenas observações qualitativas podem ser feitas.
Medições macroscópicas I-V combinadas com KPFM
Conforme indicado anteriormente, nossa primeira abordagem foi realizar medições macroscópicas de I-V em um dispositivo SiNW RJ completo. Para tanto, utilizamos um SourceMeter KEITHLEY 2450 e um microposicionador com agulha de tungstênio que permite o contato com o dispositivo estando sob a configuração AFM conforme esquematizado na Fig. 1.
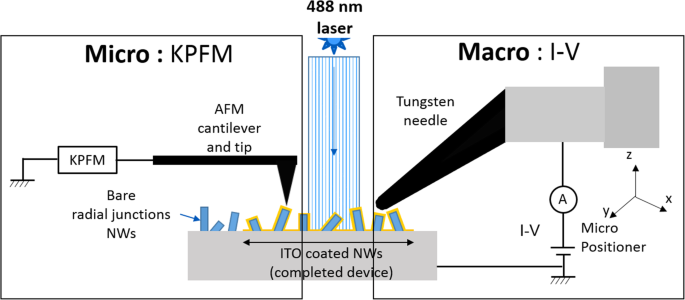
Esquemas da configuração de medição para ambas as medições KPFM e macroscópicas I-V
As medições I-V e KPFM foram realizadas em condições de escuridão e, em seguida, usando a mesma iluminação descrita na subseção anterior, ou seja, uma fonte de laser a 488 nm com potência ajustável. A iluminação foi realizada pela parte superior através de uma objetiva MITUTOYO 10X e a iluminação de potência incidente foi calibrada na faixa de 70 -1000 μW.
As medições KPFM foram posteriormente realizadas nos dispositivos isolados com dois tipos de pontas AFM, ARROW e ATEC. A iluminação da amostra durante a medição foi feita nas duas direções, superior e lateral, e utilizando a mesma potência nominal das utilizadas anteriormente no dispositivo concluído.
Resultados e discussão
Antes de iniciar as medições I-V e KPFM, o impacto do LBBDS do AFM foi investigado. De fato, já foi demonstrado que o comprimento de onda do LBBDS pode ter uma interação significativa com amostras fotovoltaicas [8,9,10] e, portanto, pode influenciar as medições de propriedades elétricas com o AFM. A Figura 2 ilustra as medições macroscópicas I ‑ V de um concluído O dispositivo SiNW RJ funcionou em condições de escuridão (LBBDS desligado) e quando o LBBDS é mantido ligado. Como mencionado anteriormente, as medições também foram realizadas em uma configuração diferente de AFM usando um comprimento de onda de 690 nm em vez de 1310 nm para o LBBDS. As curvas I-V obtidas no escuro e com o LBBDS em 1310 nm são quase idênticas. Somente ao fazer zoom em torno da origem é possível observar um deslocamento muito pequeno para as medições realizadas com o LBBDS mantido ligado, que pode ser expresso por valores muito pequenos em termos de V OC (0,5 mV) e corrente de curto-circuito, I SC, (1 nA). Em comparação, a curva I-V medida com o sistema usando um comprimento de onda de 690 nm para o LBBDS exibe um efeito fotovoltaico significativo, com valores de V OC e eu SC de 545 mV e 28 μA, respectivamente. Isso evidencia claramente o efeito perturbador de um LBBDS com um comprimento de onda do laser na faixa visível. Esses resultados mostram as dificuldades para realizar medições KPFM em condições de escuridão real quando, em particular, o comprimento de onda LBBDS pode interagir com a amostra. Os resultados ilustrados a seguir foram todos realizados com o LBBDS do AFM operando em 1310 nm descrito na subseção Kelvin-Probe.
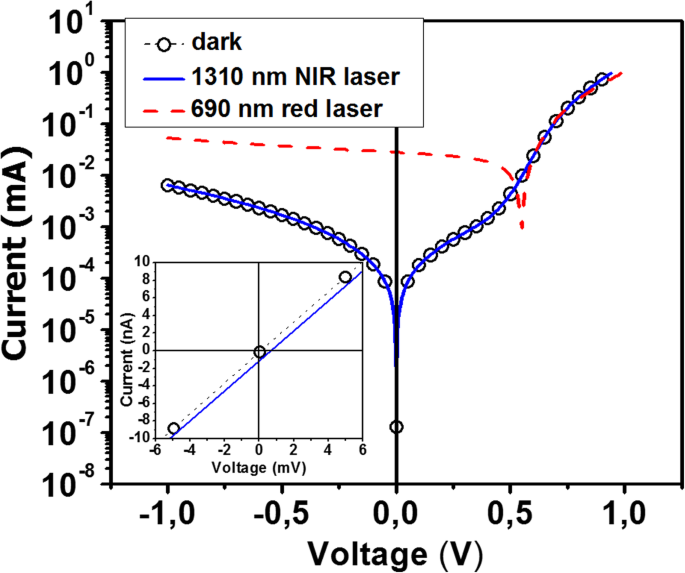
Curvas I-V obtidas em aparelho SiNW RJ no escuro (círculos pretos), com o feixe de laser 1310 nm do TRIOS AFM (linha contínua azul) e com o feixe de 690 nm do Enviroscope AFM (linha tracejada vermelha). O gráfico principal ilustra as curvas log | I | -V no intervalo - 1 V e + 1 V, e o gráfico de inserção representa uma ampliação das curvas I-V lineares entre - 5 mV e + 5 mV
Um exemplo de medição fotovoltaica em um dispositivo SiNW RJ completo é exibido na Fig. 3. Em particular, as medições macroscópicas I-V sob diferentes iluminações de energia (70, 150, 270 e 560 μW) são apresentadas na Fig. 3.a. As curvas I-V mostram um comportamento operacional típico de célula PV, onde I SC e V OC aumentar com a potência da luz incidente. A Figura 3.b mostra um exemplo de mapeamento KPFM que representa, da esquerda para a direita, a topografia, o CPD no escuro e o CPD sob iluminação 488 nm. A varredura da topografia revela NWs com alturas de várias centenas de nanômetros e mostrando uma densidade por unidade de área de cerca de 10 9 cm -2 . As varreduras de CPD exibem variações potenciais locais de cerca de ± 10 mV ocorrendo principalmente nas bordas NW. Essas variações podem ser consideradas artefatos devido à rápida mudança na topografia que a ponta do AFM passa durante o movimento de varredura e, em particular, quando passa entre dois NWs. Os locais que estão isentos de tal artefato são o topo dos NWs onde a mudança de altura da topografia permanece insignificante. Todos os valores de CPD apresentados a seguir foram extraídos no topo das NWs.
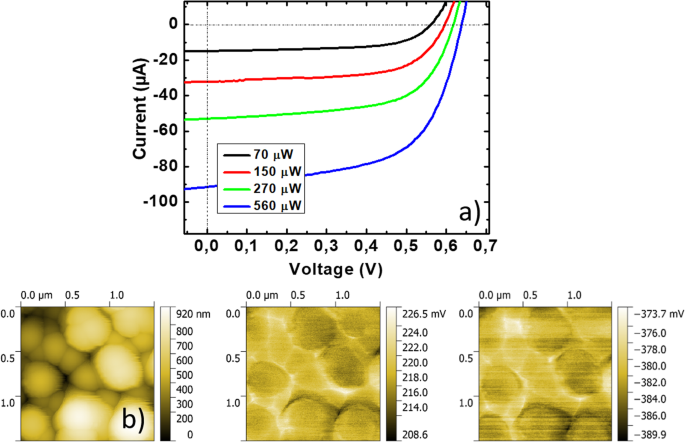
a Curvas macroscópicas I-V medidas sob diferentes iluminações de potência (66, 5, 149, 268 e 555 μW a 488 nm); b da esquerda para a direita:topografia, CPD no escuro e CPD sob iluminação (270 μW a 488 nm), respectivamente
A Figura 4 compara o V OC e valores de SPV extraídos das medições macroscópicas de I-V e KPFM como funções da potência de iluminação incidente. Essa comparação foi realizada para dois dispositivos diferentes concluídos e ilustrada em uma escala semilogista. A diferença máxima entre as curvas Voc e SPV é inferior a 5% para a potência de iluminação mais baixa (~ 70 μW) e torna-se inferior a 2% para a potência de iluminação superior. É importante notar que a barra de erro associada à avaliação experimental da potência da luz incidente aumenta quando a potência de iluminação diminui, o que pode explicar a diferença de 5% entre V OC e SPV mencionados anteriormente. Para ambos os gráficos, o SPV e V OC os valores seguem um comportamento logarítmico com valores na faixa de 500-600 mV. As inclinações de Voc e SPV fornecem um fator de idealidade (n) de 1,5 ± 0,1 para o dispositivo 1 e 1,75 ± 0,25 para o dispositivo 2, respectivamente. Esses valores estão em boa concordância com os valores relatados na literatura para a junção a-Si:H P-I-N que estão na faixa de 1,5-2 [12,13,14]. Na Fig. 5, ilustramos as medições de SPV versus potência de luz realizadas em dispositivos SINW RJ isolados. O termo isolado se refere aqui ao fato de que os RJs do nanofio não são cobertos com ITO, portanto, eles não são conectados eletricamente através da camada condutora superior. Como um guia de referência, a curva SPV obtida anteriormente para o dispositivo RJ completo na Fig. 4.a também foi mostrada na Fig. 5. Os valores SPV relatados correspondem a um valor médio resultante de vários NWs para tamanhos de varredura de 3x3 μm². As medições de SPV em dispositivos isolados foram realizadas primeiro com uma ponta de AFM em forma de seta (ARROW-EFM) e uma iluminação vinda de cima, assim como a medição de SPV realizada no dispositivo concluído. Os valores de SPV muito baixos para esta curva (Fig. 5.a, quadrados), bem como sua inclinação abaixo de 1 (~ 0,4), sugere um efeito de sombra devido à ponta de AFM. De fato, manter a mesma iluminação superior e alterar a ponta do AFM por uma sonda inclinada (ATEC-EFM) nos permitiu observar um aumento de 40% dos valores de SPV para a mesma faixa de iluminação de potência (Figura 5.b, triângulo). Resultados semelhantes foram obtidos ao mudar a iluminação do topo para o lado e substituir a ponta AFM ATEC pela SETA da ponta AFM inicial (Fig. 5.c, pontos azuis). Embora os valores de SPV tenham aumentado significativamente em comparação com as medições com iluminação superior e ponta ARROW-EFM, eles permanecem abaixo da referência enquanto mantêm inclinações semelhantes (~ 1,3-1,4). Observe que esse efeito de sombra não foi observável no caso de dispositivos concluídos, pois para esta configuração, o SPV imagens a fotovoltagem de todo o dispositivo:milhares de nanofios conectados entre si pelo contato frontal do ITO.
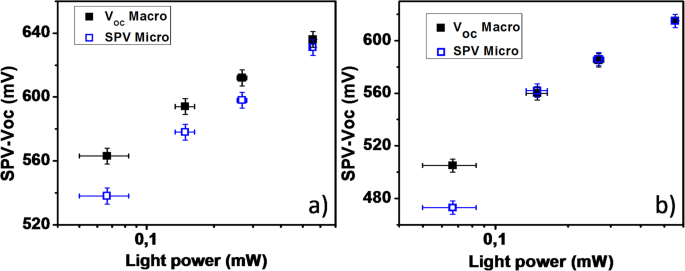
V OC e SPV versus potência de luz para dois dispositivos diferentes:dev 1 ( a ) e dev 2 ( b )

SPV versus potência de luz obtida em RJ NWs isolados. As medições foram realizadas com diferentes formatos de ponta de AFM (ARROW-EFM e ATEC-EFM) e diferentes direções de iluminação (superior e lateral). O dispositivo RJ de referência designa o dispositivo 1 ilustrado na Fig. 4a. A imagem AFM no canto inferior direito mostra um exemplo da topografia medida em NWs isolados
Para complementar esses resultados, a análise SPS qualitativa foi realizada acima de um grupo de dispositivos isolados e, em seguida, acima de um dispositivo concluído. A Fig. 6.a exibe os espectros de SPV obtidos com diferenças claras em todo o espectro. É interessante sublinhar que o dispositivo concluído mostra um SPV insignificante (~ 10 mV) na região do infravermelho próximo (NIR) com um limite de SPV ocorrendo em torno de 800 nm e abaixo do qual o SPV aumenta rapidamente atingindo um máximo de 560 mV em 630 nm. Por outro lado, o grupo de dispositivos isolados revela um SPV significativo de 80-260 mV no NIR (800-1000 nm) que aumenta gradualmente com a diminuição do comprimento de onda, até 435 mV para 665 nm. Abaixo de 665 nm e 630 nm, ambas as curvas SPV diminuem com a diminuição do comprimento de onda, o que pode estar ligado à diminuição esperada da irradiância da lâmpada de halogênio usada nesta configuração (como mencionado acima, a abordagem SPS aqui é baseada em medições qualitativas, uma vez que o fluxo não pode ser mantida constante). Em uma segunda abordagem, as medições de SPS foram realizadas em um dispositivo concluído e após a remoção local do contato superior do ITO com solução de HF a 1% aplicada como uma gota no dispositivo. A Figura 6.b ilustra essas medições, e os espectros de SPV foram coletados especificamente logo após a remoção do ITO e 72 horas depois. A remoção da camada ITO tem um grande efeito no espectro SPV quando comparado ao dispositivo concluído. Uma forte diminuição do sinal de SPV é observada na faixa de 400-750 nm logo após a remoção do ITO. Após 72 horas, o sinal SPV estabiliza em um nível mais alto, que pode diferir, dependendo do comprimento de onda, em mais de um fator de 2. Acontece também que o sinal SPV aumenta ligeiramente em comprimentos de onda mais longos (λ> 750 nm). Comparando os espectros de SPV da Fig. 6, parece que após a remoção de ITO ilustrada na Figura 6.b e especialmente após 72 h de estabilização, os dispositivos NW mostram um estado semelhante do que aqueles designados como grupo de NWs isolados na Fig. 6.a, este último nunca teve qualquer revestimento ITO. Outra observação importante diz respeito ao sinal SPV medido a 488 nm, cujo valor é um fator ~ 1,7 menor para um grupo de NWs isolados do que para um dispositivo completo. Esta observação suporta os resultados de SPV da Fig. 5 realizados por KPFM em RJs NW isolados com uma iluminação a 488 nm. De fato, apesar da otimização do formato da ponta do AFM e das condições de iluminação, os valores de SPV medidos também foram menores que os do dispositivo concluído por um fator que varia entre 1,5 e 2, dependendo da potência de iluminação.
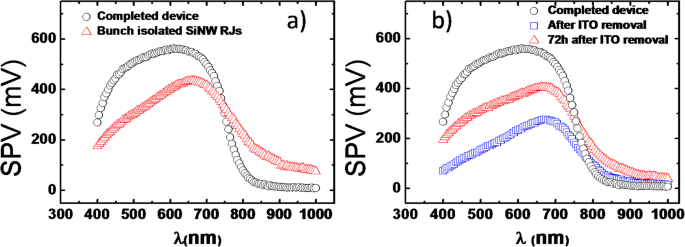
Medições SPS realizadas em a um dispositivo completo e um monte de SiNWs isolados; b um dispositivo completo, logo após a remoção do ITO, e 72 h depois
Os resultados da Fig. 6 mostram claramente que o contato superior ITO é necessário para desenvolver valores mais elevados de SPV (ou seja, V OC ) e, mais especificamente, o ponto-chave continua sendo a interface (n) a-Si:H / ITO. Esta interface é caracterizada por uma camada muito fina do tipo n a-Si:H (~ 10 nm) para favorecer a transmissão óptica. O nível de dopagem desta camada e a função de trabalho ITO podem, em particular, causar o esgotamento total da camada a-Si:H. Assim, uma queda repentina de potencial pode ocorrer na interface antes de atingir um potencial de banda plana no ITO. Tal queda no potencial na interface com o contato superior do ITO já foi ilustrada nas estruturas P-I-N a-Si:H que foram analisadas por perfis SPV [12, 15]. Mesmas interfaces com camadas ultrafinas a-Si:H também foram investigadas na tecnologia de células solares de heterojunção a-Si:H / Si cristalino enfatizando novamente o impacto do nível de dopagem e a espessura da camada a-Si:H no V OC com e sem ITO [16, 17].
As considerações anteriores indicam que a análise de SPV local por KPFM em RJs NW isolados não pode refletir quantitativamente o valor ideal de V OC devido à ausência de ITO. O V OC local extraído é aqui restrito pela curvatura da banda superficial como consequência do esgotamento total da camada a-Si:H tipo n e seu estado de superfície de oxidação. O SPV medido não inclui apenas o V OC mas também a mudança de flexão de banda induzida por foto perto da superfície da camada a-Si:H tipo n [18].
Conclusão
Dispositivos concluídos baseados em RJ SiNWs foram analisados em conjunto sob iluminação por medições I-V e KPFM. Esta primeira comparação realizada para diferentes potências de iluminação mostra que os valores SPV locais extraídos do KPFM estão muito próximos do V OC valores obtidos na análise I-V. As medições locais de SPV em SiNWs RJ isolados mostram, ao contrário, uma diferença significativa do V OC anterior valores. Um efeito de sombra da ponta do AFM foi evidenciado e minimizado alterando a forma da ponta e / ou a orientação da iluminação. Os valores de SPV otimizados coletados de RJ SiNWs isolados mostram um comportamento logarítmico com a potência de iluminação, mas permanecem bem abaixo de V OC valores de referência. A análise SPS realizada em grupos de dispositivos SiNW isolados destaca a ausência da interface (n) a-Si:H / ITO como a causa da perda de potencial, e principalmente porque os dispositivos SiNW isolados estudados não têm ITO como contato superior. Apesar disso, o SPV local extraído em dispositivos SiNW isolados sob diferentes condições de iluminação mostra uma correspondência linear com o V OC medido em dispositivos concluídos, confirmando em particular que o SPV local pode espelhar o V OC .
Disponibilidade de dados e materiais
Os conjuntos de dados usados e / ou analisados durante o estudo atual estão disponíveis junto ao autor correspondente, mediante solicitação razoável.
Abreviações
- AFM:
-
Força atômica microscópica
- AM:
-
Modulação de amplitude
- a-Si:H:
-
Silício amorfo hidrogenado
- Cg:
-
Copo Corning
- CPD:
-
Diferença de potencial de contato
- FM:
-
Modulação de frequência
- ITO:
-
Óxido de índio-estanho
- I-V:
-
Corrente electrica
- KPFM:
-
Microscopia de força de sonda Kelvin
- LBBDS:
-
Sistema de deflexão baseado em feixe de laser
- n:
-
Fator de idealidade
- NW:
-
Nanowire
- PECVD:
-
Deposição de vapor químico intensificada por plasma
- PV:
-
Fotovoltaico
- RJ:
-
Junção radial
- SiNW:
-
Nanofio de silício
- SPS:
-
Espectroscopia de fotovoltagem de superfície
- SPV:
-
Fotovoltagem de superfície
- V OC :
-
Voltagem de circuito aberto
Nanomateriais
- Imagens de átomos em cristais atômicos 2D em líquidos
- Cientistas de materiais ensinam nanofios a 'dançar'
- Absorção de luz aprimorada por plasma em células solares nanowire de GaAs de junção (p-i-n):um estudo de método de simulação FDTD
- Nanofios de silício amorfo cultivados em filme de óxido de silício por recozimento
- Investigação teórica de nanofios de germânio deformados biaxialmente por tração
- Estudo da Força de Adesão e Transição de Vidro de Filmes de Poliestireno Fino por Microscopia de Força Atômica
- Sensor de Nanofios de Óxido de Cobre Assistido por Luz Ultravioleta
- Redução do óxido de grafeno a baixa temperatura:Condutância elétrica e microscopia de varredura de força de sonda Kelvin
- Imersão potencial em fotovoltaicos orgânicos sondados por microscopia de força de sonda Kelvin transversal
- O que é Força Radial?



