Efeito da concentração de Ag disperso em filmes finos HfOx na troca de limiar
Resumo
Uma corrente de passagem secreta - uma corrente que passa por uma célula de memória vizinha - é um problema inerente e inevitável em uma matriz transversal que consiste em células de memória de memristor. Esse sério problema pode ser aliviado conectando-se em série o dispositivo seletor a cada célula de memristor. Entre os vários tipos de conceitos de dispositivo seletor, o seletor difusivo atraiu considerável atenção devido ao seu excelente desempenho. Este seletor apresenta comutação de limiar volátil (TS) usando a dinâmica de metais ativos como Ag ou Cu, que atuam como um eletrodo ou dopante no eletrólito sólido. Neste estudo, um seletor difusivo baseado em HfO dopado com Ag x é fabricado usando um sistema de co-sputtering. Como a concentração de Ag no HfO x camada varia, diferentes propriedades elétricas e, portanto, características de TS são observadas. A necessidade do processo de eletroformação (EF) para a característica de TS é determinada pela concentração adequada de Ag no HfO x camada. Esta diferença no processo EF pode afetar significativamente os parâmetros das características do TS. Portanto, uma condição de dopagem otimizada é necessária para um seletor difusivo atingir um comportamento excelente do dispositivo seletor e evitar um processo de EF que pode eventualmente degradar o desempenho do dispositivo.
Introdução
A memória de comutação de resistência, também conhecida como memristor, foi extensivamente estudada por décadas como uma candidata promissora para memória não volátil de próxima geração. Recentemente, dispositivos de memristor foram aplicados a sinapses artificiais e neurônios semelhantes ao seu mecanismo de comutação baseado na migração de íons para computação inspirada no cérebro [1,2,3]. Velocidade de comutação rápida (<1 ns), escalabilidade extrema (<2 nm), resistência bastante boa (até 10 11 ciclos de programação / apagamento) e estrutura de empilhamento tridimensional foram comprovados até agora em sistemas memristivos individuais [4,5,6]. Além disso, o processamento de imagens e o reconhecimento de padrões podem ser habilitados pela construção de um grande crossbar array (CBA) [1, 3, 7, 8].
No entanto, uma estrutura CBA tem um problema inerente em que um caminho de fuga atual através das células de memória de memristor vizinhas perturba as operações de gravação / leitura na célula selecionada ou parcialmente selecionada [9,10,11]. Para suprimir o problema atual do caminho de fuga e de seleção parcial, um dispositivo seletor de dois terminais pode ser conectado em série a cada célula de memória. Existem muitos tipos de dispositivos seletores com tensão de corrente não linear ( I - V ) características sendo introduzidas, como diodos Schottky, transições de metal-isolador (MITs), interruptores de limiar ovônicos (OTSs), seletores de barreira de túnel e seletores difusivos (também denominados memristores difusivos) [9,10,11,12,13,14 , 15]. Entre eles, um seletor difusivo baseado em espécies de metal (Ag ou Cu) dinâmica difusiva dentro dos dielétricos tem atraído considerável interesse por sua estrutura simples e desempenho superior, como sua não linearidade extremamente alta [14,15,16,17,18, 19,20,21,22]. O seletor difusivo apresenta uma chave de limiar volátil (TS) com base na formação e autorruptura de filamentos metálicos. Vários sistemas seletores difusivos e suas propriedades dinâmicas foram relatados até agora; no entanto, a compreensão do mecanismo de operação subjacente continua difícil. Além disso, é necessário estabelecer a concentração e distribuição das espécies de metais difusivos para obter um excelente desempenho de TS, pois estes podem afetar significativamente as propriedades de condução e transição elétrica.
Aqui, nós fabricamos um HfO dopado com Pt / Ag x / Pt pilha como um seletor difusivo, em que Ag e HfO x atuam como um dopante metálico difusivo e material dielétrico, respectivamente. Examinamos as propriedades elétricas dos dispositivos em diferentes concentrações de dopagem para relacionar as condições adequadas para a característica TS. As características de TS necessária de eletroformação (necessária EF) e livre de eletroformação (livre de EF) foram determinadas pela concentração de dopante nos seletores difusivos. Para explicar a diferença no processo de eletroformação (EF) e as características de TS subsequentes, realizamos análises estruturais e químicas dos dispositivos seletores difusivos. Nosso estudo sugere o efeito da concentração de dopante nas características de TS do seletor difusivo e fornece uma direção para melhorar seu desempenho.
Métodos
A Figura 1a mostra um sistema de co-pulverização catódica com um Ag e HfO 2 alvo. Fabricamos dispositivos colocados em quatro posições no substrato com 0,5 cm de distância um do outro. As posições eram próximas ao HfO 2 alvo na ordem do dispositivo 1, 2, 3 e 4 (D1, D2, D3 e D4) como mostrado na Fig. 1a. O HfO dopado com Ag x camada de comutação de todos os dispositivos foi depositada no Pt / Ti / SiO 2 Substrato / Si via co-sputtering com um poder de sputtering de 10 W para Ag e 150 W para HfO 2 , respectivamente. Antes do processo de deposição, a pressão de base da câmara de vácuo foi evacuada até ~ 5 × 10 6 . A camada de troca foi depositada por 5 min sem girar o substrato à temperatura ambiente sob um fluxo de Ar de 20 sccm para manter o plasma de Ar. A pressão do processo era de 10 mTorr. Posteriormente, o eletrodo de Pt superior foi depositado em uma camada de comutação conforme depositada usando uma máscara de sombra de 200 μm de diâmetro por meio de evaporação de feixe eletrônico. As Figuras 1 bec mostram a imagem em corte transversal e o design esquemático do dispositivo fabricado, respectivamente.
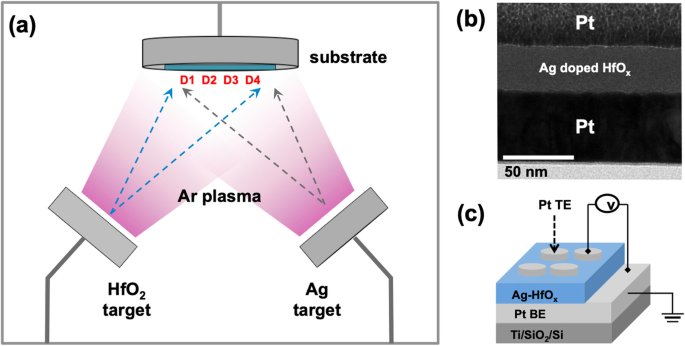
a Diagrama esquemático de um sistema de co-sputtering. b Imagem TEM em corte transversal do dispositivo fabricado. c Diagrama esquemático do dispositivo com o sistema de medição elétrica
A espessura da camada de comutação depositada via co-sputtering foi medida usando um elipsômetro (FS-1, Film-Sense, EUA). A espectrometria de retroespalhamento de Rutherford (RBS; 6SDH-2, NEC, EUA) e a espectrometria de fluorescência de raios-X (XRF; ARL, Thermo Fisher Scientific, EUA) foram realizadas para analisar a composição atômica do HfO dopado com Ag x camada. Para avaliação das propriedades elétricas do dispositivo, foi utilizado um analisador de parâmetros semicondutores (SPA; HP-4155A, Agilent, EUA) em temperatura ambiente. Todas as medições foram realizadas aplicando uma polarização ao eletrodo superior enquanto o eletrodo inferior era aterrado, conforme mostrado na Fig. 1c. A superfície dos dispositivos foi analisada usando um microscópio eletrônico de varredura por emissão de campo (FE-SEM; JSM-6700F, JEOL, Japão) e uma microscopia de força atômica (AFM; XE-100, sistema Park, Coréia). As amostras transversais dos dispositivos foram preparadas usando um processo de feixe de íons focalizado (FIB; Quanta 3D FEG, FEI, Holanda) e foram observadas usando um microscópio eletrônico de transmissão de alta resolução (HR-TEM:JEM-2100F, JEOL, Japão ) A composição química foi analisada por espectroscopia de energia dispersiva de raios-X (EDS).
Resultados e discussão
Nós fabricamos simultaneamente quatro HfO dopados com Ag x dispositivos para seletores difusivos durante um único processo. Durante o processo de deposição, o substrato não foi girado para confirmar o efeito da concentração de dopagem nas propriedades elétricas. A Tabela 1 mostra a espessura, a razão do cátion Ag:Hf e a rugosidade quadrática média (RMS) de D1, D2, D3 e D4, respectivamente. A composição de Ag na camada de comutação foi expressa como uma razão de cátions usando uma quantidade de Ag e Hf obtida a partir da análise de XRF. Conforme mostrado, cada dispositivo tem uma espessura e concentração de Ag diferentes. Com um aumento na distância do HfO 2 alvo, a espessura da camada de comutação diminuiu enquanto a composição de Ag na camada de óxido aumentou. Com o aumento da concentração de Ag, os valores de rugosidade RMS aumentaram ligeiramente (imagens AFM são mostradas no arquivo adicional 1:Figura S1).
Corrente contínua (DC) - tensão ( I - V ) características medidas de todos os dispositivos são mostradas na Fig. 2a – d. D1 (35,3 nm, 7% Ag) estava inicialmente em um estado altamente isolante, e nenhuma mudança de limiar foi observada durante as medições DC (Fig. 1a) devido à concentração insuficiente de Ag para produzir um filamento condutor, apesar da espessa camada de comutação. Em contraste, D2 (27,3 nm, 16% Ag) mostrou um limiar de mudança de um estado de alta resistência (HRS) para um estado de baixa resistência (LRS) após o processo de eletroformação (EF) no estado original para produzir um dispositivo operável como mostrado na Fig. 1b. Durante o processo de EF, a corrente aumentou de um nível baixo para atingir uma corrente de conformidade ( I cc ) na tensão de - 4,3 V. Depois disso, D2 mostrou continuamente o comportamento de TS em uma tensão de operação mais baixa do que a tensão de formação em ambas as polaridades de polarização. Da mesma forma, D3 (24 nm, 39% Ag) mostrou um comportamento TS bidirecional típico; no entanto, o processo EF não era necessário no estado primitivo de D3. Em outras palavras, D3 apresenta comportamento de TS livre de EF. Em contraste, D4 (18,8 nm, 58% de Ag) estava inicialmente em um estado altamente condutor, provavelmente por causa da percolação de Ag dentro do HfO fino x camada dada a alta concentração de Ag.

Propriedades elétricas dos dispositivos fabricados. a I-V curva de D1 (estado altamente isolante). b I-V curva de D2, mostrando o processo de EF e os comportamentos de TS subsequentes. c I-V curva de D3, mostrando o comportamento TS sem o processo EF. d I-V curva de D4 (estado condutor)
A morfologia da superfície e o tamanho do grão mudaram com o aumento da concentração de Ag. Conforme observado anteriormente, com o aumento da concentração de Ag, os valores de rugosidade RMS aumentaram conforme mostrado na Tabela 1. O tamanho do grão também foi avaliado usando um SEM (Arquivo adicional 1:Figura S2). Um aumento no tamanho do grão foi observado com o aumento da concentração de Ag. No entanto, no caso de D2 e D3 que apresentam características distintas de TS, a diferença na rugosidade da superfície e no tamanho do grão foi muito pequena. No entanto, houve uma diferença considerável em suas propriedades elétricas em termos do processo EF e seguindo as características do TS. Assim, comparamos ainda as características de TS de D2 e D3 como segue.
As Figuras 3 aeb mostram o comportamento de TS repetível observado em D2 e D3 via medição DC. Para comparação, apenas as características de TS na polarização negativa são mostradas nas figuras. Ambos os dispositivos mostraram inicialmente vários níveis de corrente pA em - 0,1 V abaixo do limite de detecção. O comportamento de TS em D2 foi evidente após o processo EF em uma tensão de formação de ~ - 3,5 V, enquanto uma corrente de conformidade ( I cc ) de 5 μA foi definido para o dispositivo para evitar uma falha grave. Seguindo o processo EF, o dispositivo mostrou um comportamento típico de TS, conforme mostrado na Fig. 3a. Quando a tensão aplicada excedeu a tensão limite ( V th ) de ~ - 1,1 V, a corrente de repente atingiu um I cc de 5 μA; o dispositivo mudou para o estado ON a partir do estado OFF. No entanto, o estado LIGADO do dispositivo recuperou para o estado DESLIGADO quando a tensão aplicada diminuiu para menos do que a tensão de retenção ( V espera ) Embora o dispositivo tenha retornado ao estado OFF, uma corrente OFF mais alta foi observada do que a do dispositivo antes do EF.
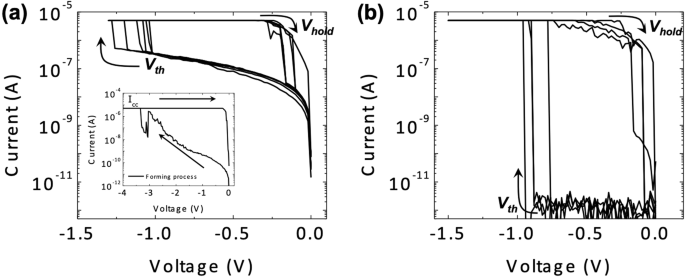
Comparação das características de TS em D2 e D3. a Comportamento de TS com uma corrente OFF aumentada seguindo o processo EF. A figura inserida mostra o processo EF em um dispositivo como depositado. b Comportamento de TS sem o processo EF mantendo uma baixa corrente OFF e alta NL
D3 também mostrou características TS típicas, conforme mostrado na Fig. 3b. No entanto, o processo EF não foi necessário para induzir o comportamento de TS no dispositivo no estado original. A corrente atingiu um I cc de 5 μA em um V th de ~ - 0,8 V, que é o estado LIGADO, e então voltou espontaneamente ao estado DESLIGADO inicial em um V th menor que ~ - 0,2 V. O D3 subsequente I - V loops eram semelhantes ao primeiro I - V rotações. Além disso, o dispositivo mostrou consistentemente uma baixa corrente OFF em uma baixa tensão de operação em comparação com a de D2. Além disso, a densidade de corrente no estado OFF em D3 ainda permaneceu menor do que em D2; a diferença foi de aproximadamente 10 5 A / cm 2 . Consequentemente, foi confirmado que a diferença na concentração de Ag no HfO x A camada determinou a necessidade do processo EF e, por sua vez, as características do TS mudaram dramaticamente.
Para realizar uma memória resistiva de um seletor-um (1S1R), um seletor requer uma corrente OFF baixa para suprimir a corrente de fuga e uma corrente ON alta correspondente à corrente de reset da memória resistiva [21, 22]. Para cumprir tal eu - V características não lineares, confirmamos a não linearidade ( NL ) e seletividade ( S ) de nossos dispositivos e aqueles de seletores de TS relatados anteriormente para avaliar seu desempenho como seletores [14, 18, 21,22,23]. Aqui, definimos NL e S usando Eqs. (1) e (2), respectivamente, da seguinte forma:
$$ NL =\ frac {I_ {V _ {\ mathrm {th}}}} {I _ {\ frac {1} {2} {V} _ {\ mathrm {th}}}} $$ (1) $$ S =\ frac {I _ {\ mathrm {LIGADO}}} {I _ {\ mathrm {DESLIGADO}}} $$ (2)
NL é definido como a razão da corrente em V th e metade de V th . No esquema de meia polarização na matriz da barra transversal, V th é aplicado à célula de segmentação enquanto metade de V th é aplicado às células semi-selecionadas vizinhas. Portanto, NL é fundamental para evitar o mau funcionamento da matriz da barra transversal durante as operações de programa / leitura. Em contraste, S é a proporção da corrente no estado LIGADO e no estado DESLIGADO em V th , representando o desempenho do seletor baseado em TS. Ambas as definições são amplamente utilizadas para a comparação do desempenho do dispositivo seletor. Assim, grande NL e S os valores são necessários para a operação 1S1R suprimir efetivamente a corrente do caminho de fuga.
Vários parâmetros de comutação, incluindo NL e S em nossos dispositivos e os seletores de TS na literatura são mostrados na Tabela 2. No caso de D2, um aumento na corrente OFF causa uma diminuição significativa em NL e S . Em contraste, a corrente D3 OFF é suficientemente baixa para ser maior que 10 6 NL e S foram adquiridos. No entanto, D2 e D3 só puderam mostrar uma característica de TS em um baixo I cc (<10 μA) porque TS fez a transição para a comutação de memória em um I superior cc . É bem conhecido que a maioria dos dispositivos seletores de TS usando filamento Ag estão sujeitos a uma transição de comutação de memória não volátil em um I cc maior que 10–100 μA [23,24,25,26]. Quando eu cc é superior a 10-100 μA, um filamento de metal robusto e estável é formado e é difícil de romper espontaneamente em comparação com o filamento fino e instável formado em um I inferior cc [26, 27]. Portanto, vários métodos, como uma estrutura de multicamadas (Ag / TaO x / TaO y / TaO x / Ag) e nanopontos de Ag modelados no dielétrico, foram sugeridos para obter características confiáveis de TS em um I superior cc [21, 22].
Para observar o tamanho e distribuição dos átomos de Ag dentro do HfO x camada, HR-TEM e análises elementares EDS foram realizadas em D2 e D3. A Figura 4 a e b (c e d) mostram imagens HR-TEM em seção transversal de D2 (D3). De acordo com as imagens HR-TEM, é provável que o tamanho atômico Ag seja uniformemente disperso no HfO x matriz. Nenhuma partícula de Ag distinguível ou aglomerados de Ag com alguns nanômetros de tamanho foram observados em ambos os dispositivos. Além disso, o HfO x a fase amorfa foi confirmada por meio de uma imagem de transformada rápida de Fourier (FFT), como mostrado nas inserções da Fig. 4 b e d. No entanto, o sinal de Ag nos perfis de linha indica a presença de Ag no HfO x camada. Assim, conclui-se que Ag em HfO x seria distribuído em escala atômica. A região de comutação incluindo o nanofilamento de Ag deve ser investigada; no entanto, as características de TS são voláteis, de modo que a observação de TEM in situ deve ser tentada no futuro.
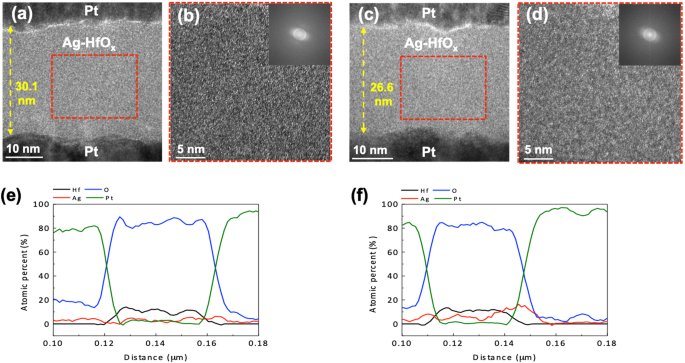
Análise microestrutural e composicional. a Imagem transversal TEM de D2. b Imagem TEM ampliada de D2. A inserção é a imagem FFT correspondente. c Imagem transversal TEM de D3. d Imagem TEM ampliada de D3. A inserção é a imagem FFT correspondente. Perfis de linha elementar EDS de e D2 e f D3
Propomos o seguinte mecanismo para comportamentos de TS em nossos dispositivos como mostrado nas Fig. 5 a e b. O HfO dopado com Ag conforme fabricado x camadas de comutação têm átomos de Ag uniformemente distribuídos no HfO x . No entanto, é esperado que haja uma distância relativamente longa entre os átomos de Ag devido à baixa concentração de Ag em D2. A Figura 5a mostra o processo EF do D2 como fabricado. Quando um campo elétrico é aplicado ao dispositivo em um estado puro, átomos de Ag no HfO x pode ser oxidado em Ag + íons e eles migram ao longo da direção do campo. O Ag oxidado + os íons são reduzidos a átomos de Ag novamente no outro eletrodo de Pt, onde um filamento condutor de Ag pode crescer continuamente. Uma vez que o filamento é conectado entre os dois eletrodos, o dispositivo é comutado para um estado LIGADO a partir de um estado DESLIGADO. Durante o processo EF em D2, aglomerados maiores de Ag puderam ser formados devido ao alto campo elétrico. Foi descoberto que um campo elétrico tão grande é suficiente para formar nanopartículas de Ag com vários nanômetros de diâmetro a partir da observação TEM in situ na literatura [14, 15]. Depois que o campo elétrico aplicado é removido, o Ag em escala atômica se difunde para o HfO x matriz, indicando que o dispositivo voltou ao estado DESLIGADO. No entanto, clusters maiores de Ag, que não podem se difundir suficientemente, permanecem no caminho condutor. Assim, esses aglomerados de Ag residuais levam a uma corrente OFF maior no estado OFF subsequente. Em contraste, no caso de D3 como fabricado, como mostrado na Fig. 5b, o filamento de Ag é formado sem a formação de aglomerado de Ag porque D3 é operado sob o baixo campo elétrico, o que significa que o dispositivo pode manter baixa corrente OFF. Da mesma forma, quando o campo elétrico aplicado é removido, o dispositivo retorna ao estado OFF devido à ruptura espontânea do filamento de Ag que pode ser explicada pelo efeito Thomson-Gibbs de minimizar a energia interfacial entre um filamento e a matriz [15, 18 , 28]. Consequentemente, as características de TS bidirecionais podem ser obtidas através da dinâmica difusiva de íons / átomo de Ag repetível.
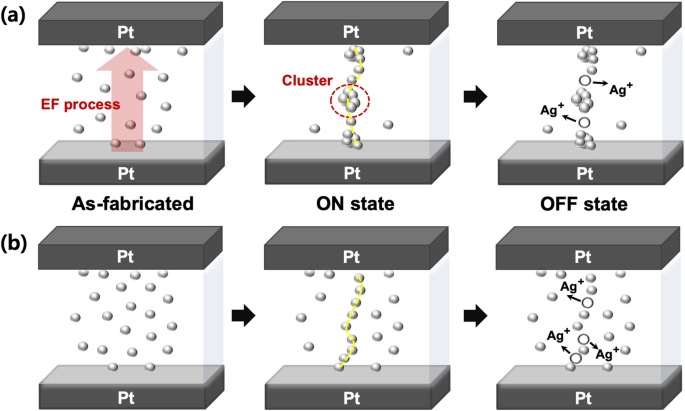
Mecanismo sugerido de TS em um dispositivo HfOx dopado com Ag. A primeira formação / ruptura de filamento de Ag para comportamento de TS em a EF necessário (D2) e b Dispositivos sem EF (D3)
Para explicar a diferença durante o processo EF, propomos as seguintes Eqs. (3) e (4):
$$ D ={D} _0 \ mathit {\ exp} \ left (- \ frac {E _ {\ mathrm {mo}}} {kT} \ right) $$ (3)
onde D é a difusividade, D 0 é o fator pré-exponencial, E mo é a barreira de migração em polarização zero, k é a constante de Boltzmann, e T é a temperatura absoluta local. Para formar o filamento Ag dentro do HfO x camada, os íons de Ag devem superar uma barreira de migração para mover em direção ao eletrodo polarizado negativamente. Quando a polarização externa é aplicada, o campo elétrico pode diminuir a barreira de migração, E m , levando a migrações de íons ao longo da direção do campo da seguinte forma:
$$ {E} _ {\ mathrm {m}} ={E} _ {\ mathrm {m} \ mathrm {o}} - \ frac {e \ bullet {V} _ {\ mathrm {bias}}} { Z _ {\ mathrm {box}}} \ bullet \ Delta z $$ (4)
com uma carga de elétron e , tensão de polarização V preconceito , HfO x espessura da camada Z caixa e distância de salto Ag no z direção ∆z . Na verdade, os íons Ag podem saltar em todas as direções sob polarização zero. No entanto, consideramos o salto ao longo do z direção no processo EF porque o dispositivo pode ser colocado no estado ON sob o campo elétrico alto, onde os íons Ag saltam predominantemente ao longo da direção do campo elétrico. Para estimar o E m , calculamos a distância de salto Ag ( ∆z ) como 0,67 nm em D2 e 0,45 nm em D3 de nossos resultados experimentais de concentração de Ag e espessura do filme. A barreira de migração em polarização zero, E mo =3,02 eV, foi utilizado da literatura [29]. Na primeira formação do filamento de Ag, ~ 1,6 MV / cm de campo elétrico foi necessário em D2 e diminuiu a barreira de migração em 0,11 eV. Em contraste, ~ 0,4 MV / cm de campo elétrico foi necessário para a primeira comutação em D3 e reduziu a barreira de migração em 0,04 eV. Assim, a difusão de Ag é suficiente para formar o filamento de Ag em D3, apesar da redução da barreira inferior devido à curta distância de salto e alta concentração de Ag em comparação com aqueles de D2. No entanto, por causa da distância de salto relativamente longa em D2, a redução de barreira maior foi necessária para a difusão suficiente para formar o filamento de Ag. Uma vez que o filamento se forma, ele deve se romper espontaneamente, cessando a tensão; no entanto, o filamento Ag não pode se difundir totalmente em sua distribuição inicial e, portanto, na distância de salto ∆z diminui em relação ao D2 como fabricado. Portanto, este resultado levou a um campo elétrico reduzido (~ 0,4 MV / cm) na comutação de limiar subsequente. Deve-se notar que a espessura do filme afeta consideravelmente o I - V características do dispositivo. Portanto, confirmamos o processo de EF nos dispositivos com espessuras semelhantes, mas com uma concentração de Ag diferente. Da mesma forma, os dispositivos exibiram uma transição das características de EF necessário para EF-livre com o aumento da concentração de Ag. Portanto, foi demonstrado que a concentração de Ag afeta essencialmente o processo de EF, controlando o campo elétrico interno efetivo. Ou seja, modulando a concentração de Ag e, portanto, a distância de salto no HfO x camada é necessária para características de TS livres de EF com NL maiores e S valores.
Conclusões
Dispositivos seletores difusivos baseados em HfO dopado com Ag x filmes finos foram fabricados e suas características TS foram avaliadas. Para compreender o efeito da concentração de Ag nas propriedades elétricas, foram avaliados dispositivos com diferentes concentrações de Ag. O comportamento do TS nos dispositivos pode ser descrito pela formação / auto-ruptura do filamento de Ag a partir de átomos de Ag atomicamente dispersos no HfO x . Foi confirmado que a concentração de Ag pode afetar o processo de EF para formar tal filamento metálico. O dispositivo com uma baixa concentração de Ag exigiu um processo precedente de EF para o comportamento de TS, enquanto o comportamento de TS livre de EF foi comprovado no dispositivo com uma concentração de Ag mais alta. Além disso, o dispositivo EF-free mostrou melhor desempenho de TS do que o dispositivo EF necessário em termos de não linearidade e corrente OFF. Portanto, a concentração adequada de dopante e o controle de distribuição são necessários para obter um dispositivo seletor difusivo livre de EF para evitar a degradação do desempenho resultante do processo de EF.
Disponibilidade de dados e materiais
Todos os dados estão totalmente disponíveis sem restrição.
Abreviações
- CBA:
-
Matriz de barra transversal
- EF:
-
Eletroformação
- HRS:
-
Estado de alta resistência
- LRS:
-
Estado de baixa resistência
- NL :
-
Não-linearidade
- S :
-
Seletividade
- TS:
-
Troca de limite
Nanomateriais
- Fabricação de filmes finos SrGe2 em substratos Ge (100), (110) e (111)
- Estudo da Força de Adesão e Transição de Vidro de Filmes de Poliestireno Fino por Microscopia de Força Atômica
- Efeito de campo ferroelétrico Efeito de comutação assimétrica resistiva induzida em BaTiO3 / Nb:SrTiO3 Heterojunções epitaxiais
- Análise de impedância de filmes finos de perovskitas orgânico-inorgânicas CH3NH3PbI3 com controle de microestrutura
- Nanopartículas de ouro de formato redondo:efeito do tamanho da partícula e da concentração no crescimento da raiz de Arabidopsis thaliana
- Efeito de diferentes morfologias CH3NH3PbI3 nas propriedades fotovoltaicas de células solares de perovskita
- Funções duplas do dispositivo V / SiOx / AlOy / p ++ Si como seletor e memória
- Efeito da bicamada CeO2 − x / ZnO e ZnO / CeO2 − x heteroestruturas e polaridade de eletroformação nas propriedades de comutação da memória não volátil
- Efeito do recozimento pós-térmico nas propriedades ópticas de InP / ZnS Quantum Dot Films
- Filmes finos de óxido de vanádio amorfo como cátodos de baterias de lítio e íons de sódio de desempenho estável



