Ajuste de nível de Fermi de filmes ZnO por meio de deposição de camada atômica superciclada
Resumo
Um novo processo de deposição de camada atômica superciclado (ALD) que combina o processo ALD térmico com O 2 in situ tratamento com plasma é apresentado neste trabalho para depositar filmes finos de ZnO com propriedades elétricas altamente sintonizáveis. Ambos O 2 o tempo de plasma e o número de ciclos ALD térmicos em um superciclo podem ser ajustados para alcançar o ajuste fino da resistividade do filme e da concentração de portadores em até seis ordens de magnitude sem dopagem extrínseca. Acredita-se que a concentração de defeitos de hidrogênio desempenha um papel importante no ajuste das propriedades elétricas dos filmes de ZnO. Os resultados da microscopia de força de sonda Kelvin evidentemente mostram a mudança do nível de Fermi em diferentes filmes de ZnO e estão bem associados à mudança da concentração de portadores. Esta técnica confiável e robusta relatada aqui aponta claramente para a capacidade de usar este método para produzir filmes de ZnO com propriedades controladas em diferentes aplicações.
Histórico
Uma vez definido como o material futuro , o óxido de zinco (ZnO) atraiu o interesse da comunidade científica por mais de meio século devido às suas propriedades ópticas e elétricas superiores [1]. Recentemente, o rápido crescimento da indústria de óxido condutor transparente reviveu ainda mais sua aplicação como eletrodos transparentes em telas planas, telas sensíveis ao toque, revestimento de baixa emissividade, células solares de filme fino, etc. [2, 3]. Além disso, o ZnO encontrou inúmeras aplicações em dispositivos eletrônicos, incluindo diodos emissores de luz, fotodetectores e dispositivos de energia [4, 5]. Esses diferentes tipos de aplicações requerem que os filmes de ZnO tenham vários parâmetros elétricos, e algumas aplicações ainda exigem multicamadas de filmes de ZnO com diferentes propriedades elétricas [6]. Por exemplo, numerosos esforços têm sido feitos para desenvolver memória de acesso aleatório resistiva transparente (TRRAM) para a realização de eletrônicos transparentes totalmente integrados [7, 8]. Como um dos candidatos mais promissores, o TRRAM baseado em ZnO usa um filme de ZnO altamente resistivo como a camada de comutação ativa, enquanto os filmes de ZnO altamente condutores são idealmente exigidos para atuar como eletrodos transparentes [8,9,10]. A capacidade de controlar as propriedades elétricas, como resistividade e concentração de portadores dos filmes de ZnO, é, portanto, um requisito fundamental. O dopagem é geralmente usado quando a modificação da propriedade é necessária e uma variedade de dopantes foram aplicados para alterar as propriedades do filme de ZnO [11,12,13]. Porém, o doping é sempre complexo e pode levar à formação da fase secundária [14]. A modulação das propriedades elétricas do ZnO não dopado por um único processo de deposição pode, portanto, ser vantajosa.
A deposição de camada atômica (ALD) se tornou uma técnica popular para formar ZnO de alta qualidade com um excelente controle da espessura do filme em escala nanométrica e uniformidade sobre um grande substrato [15, 16]. A temperatura de crescimento do ZnO é geralmente inferior a 200 ° C, o que o torna compatível com uma variedade de substratos, incluindo vidro e plásticos. O ALD ZnO é normalmente cultivado usando dietilzinco (DEZ) como um precursor de Zn e vapor de água (térmico) ou plasma de oxigênio (intensificado por plasma) como precursor de oxigênio. A maneira dominante de ajustar as propriedades do filme de ZnO não dopado no processo ALD térmico é alterando a temperatura de crescimento [17, 18]. Embora isso permita a deposição de filmes altamente condutores, os filmes de ZnO de alta qualidade são difíceis de obter com baixa concentração de portadores. O ALD intensificado por plasma é preferencialmente usado quando uma baixa concentração de portador de ZnO é necessária [19, 20]. Recentemente, relatamos a capacidade de ajustar ZnO usando um único processo ALD aprimorado por plasma que permite o ajuste de sua resistividade e concentração de portadores em até três ordens usando diferentes O 2 tempos de plasma [21]. No entanto, o ALD intensificado por plasma pode sofrer um crescimento não autolimitado se um curto O 2 o tempo de plasma é aplicado para atingir a concentração de transportador necessária, o que pode resultar em uma uniformidade pobre sobre um substrato grande. Um processo ALD ajustável dentro da janela autolimitada seria, portanto, desejado.
Além da capacidade de ajustar as propriedades elétricas do ZnO, a determinação dessas propriedades também permanece um desafio. A medição do efeito Hall é a técnica mais popular para medir as propriedades elétricas de filmes finos de ZnO. No entanto, pode estar sujeito a interpretações errôneas e tem dificuldade em detectar de maneira inequívoca a causa real do doping [1]. A microscopia de força de sonda Kelvin (KPFM) é uma técnica de superfície não destrutiva que tem sido amplamente utilizada para caracterizar propriedades elétricas, dinâmicas e estruturais em nanoescala de materiais e dispositivos semicondutores [22, 23]. Medindo diretamente a diferença de potencial de contato ( V CPD ), ou seja, a diferença entre as funções de trabalho da ponta e da amostra, pode fornecer uma visão sobre os tipos de dopante de material, concentrações de transportador e resistividade, pois afetam a posição do nível de Fermi dentro do bandgap. No entanto, trabalhos correlacionando as propriedades de ZnO com resultados de KPFM raramente são relatados e, até onde sabemos, não há nenhum baseado em filmes de ZnO crescidos em ALD [24,25,26].
Neste trabalho, propomos um novo processo ALD superciclado para o ajuste de propriedades elétricas em ZnO não dopado. Combinando o processo ALD térmico com um O 2 in situ tratamento de plasma, este processo permite um ajuste amplo, mas refinado, da resistividade do filme de ZnO e da concentração de portadores. Mais importante, as mudanças de nível de Fermi nos filmes de ZnO podem ser medidas diretamente pelo KPFM e usadas para caracterizar as propriedades elétricas do ZnO.
Métodos
Todos os filmes finos de ZnO foram preparados em um sistema OIPT FlexAl ALD usando um precursor de dietilzinco (DEZ). Cada superciclo do processo ALD consiste em m ciclos de processos ALD térmicos (DEZ e H 2 O) e um O 2 etapa de plasma conforme demonstrado na Fig. 1a. Dentro do processo ALD térmico, o vapor DEZ foi inicialmente introduzido na câmara e então purgado por um fluxo de argônio, e H 2 O vapor de O foi subsequentemente introduzido e então purgado com argônio. Depois de m ciclos de processos ALD térmicos, um O 2 a etapa de plasma foi adicionada como uma etapa de tratamento de plasma in situ. O 2 etapa de plasma foi definida usando um O 2 vazão de 60 sccm, potência de RF de 300 W e pressão de 15 mTorr. Ambos os números ALD térmicos ( m ) e O 2 tempo de plasma ( t 3 ) foram usados para o controle de propriedade do filme ZnO. Os detalhes específicos para um superciclo de crescimento no processo ALD são fornecidos no arquivo adicional 1:Tabela S1. Todos os filmes ZnO foram depositados no SiO 2 substratos de Si revestidos (1 cm × 1 cm) a uma temperatura fixa de 190 ° C, e todas as espessuras de filme foram projetadas em 40 nm.

a Ilustração de um superciclo de crescimento do processo ALD superciclado proposto. b Taxas de crescimento de ZnO em função do O 2 tempo de plasma para ALD superciclado com ciclo térmico fixo ( m =1) e processos ALD intensificados por plasma; as curvas tracejadas são guias do olho. c Taxa de crescimento de ZnO e ajuste linear em função do ciclo do processo térmico m com O 2 fixo tempos de plasma ( t 3 =1 e 8 s)
A espessura e as constantes ópticas dos filmes de ZnO depositados foram medidas por elipsometria (VASE, J.A. Woollam Co. M-2000) e ajustadas com um modelo Tauc-Lorentz (TL). As propriedades elétricas foram medidas por medições Hall (Nanometrics HL5500PC) em temperatura ambiente sob um campo magnético de 0,5 T. Um cuidado extra foi tomado para garantir que o contato linear fosse obtido entre cada sonda de cobre e a amostra antes de cada medição. Os padrões de difração de raios-X (XRD) foram coletados na incidência de pastagem ( θ 1 =1 °) usando um difratômetro Rigaku Smartlab com um Cu- K de 9 kW α fonte. Os dados de espectroscopia de fotoelétrons de raios-X (XPS) foram obtidos usando um Thermo Scientific Theta Probe System com Al- K α radiação (energia do fóton =1486,6 eV). Quando necessário, a contaminação da superfície foi eliminada pelo uso de uma pistola de pulverização de íons. O Zn 2 p , O 1 s , e C 1 s espectros foram coletados. Todos os dados foram referenciados ao C 1 s pico, ao qual foi atribuída uma energia de ligação de 284,6 eV. As medições KPFM foram realizadas no Nanonics CV2000 por uma ponta revestida com Nanosensor ATEC Pt-Ir com uma frequência de ressonância de 65 kHz. Para reduzir a influência do contaminante superficial, as medições foram realizadas logo após as amostras serem removidas da câmara de vácuo.
Resultados e discussão
O processo ALD superciclado proposto é ilustrado na Fig. 1a com um superciclo consistindo em m ciclos de processos ALD térmicos (DEZ e H 2 O) e um O 2 etapa de plasma (O 2 plasma). Mais detalhes estão na seção “Métodos”. A Figura 1b compara as taxas de crescimento de ZnO em nosso processo ALD superciclado quando m =1 e o processo ALD intensificado por plasma convencional como uma função de O 2 tempo de plasma. A taxa de crescimento no processo ALD intensificado por plasma (vermelho) é considerada sensível ao O 2 plasma à medida que aumenta de ca. 1,4 a 1,7 Å / ciclo com o tempo de plasma mudando de 2 a 4 s. Em seguida, é saturado ao nível de ca. 1,7 Å / ciclo em tempos de plasma mais longos. A taxa de crescimento insaturado em O 2 mais curto o tempo de plasma é atribuído à deficiência de oxigênio no processo. Embora isso às vezes seja preferido para obter filmes de ZnO com alta condutividade, não é autolimitado e pode resultar em uma uniformidade pobre em todo o substrato. Por outro lado, a taxa de crescimento foi considerada estável em ca. 1,69 Å / superciclo no processo ALD superciclado (preto) e é próximo ao do processo ALD térmico ( t 3 =0 s) independentemente do tempo de plasma aplicado. Além disso, aumento do ciclo térmico m em um superciclo com tempo de plasma fixo leva a um aumento linear da taxa de crescimento, conforme mostrado na Fig. 1c. O gradiente ajustado é calculado em 1,67 para ambos os crescimentos com O 2 diferente tempos de plasma, que também estão próximos da taxa de crescimento do processo ALD térmico. Isso sugere que o crescimento de ZnO em nosso ALD superciclado é dominado pelo processo ALD térmico e o subsequente O 2 a etapa de plasma serve apenas como um tratamento.
Todos os filmes ZnO crescidos pelo processo ALD superciclado ( m =1) cristalizar na estrutura wurtzita hexagonal e ilustrar uma distribuição semelhante de intensidades de pico, independentemente do O 2 tempo de plasma, como mostrado na Fig. 2a. Comparado com a razão de intensidade teórica de 0,44 entre o pico (0 0 2) e (1 0 1) (calculado a partir de JCPDS-34-1451 para uma orientação aleatória dos cristalitos), esses filmes demonstram uma forte orientação preferencial ao longo do c -eixo com a razão de intensidade de pico (0 0 2) e (1 0 1) entre 2 e 5, sugerindo boa qualidade cristalina dos filmes. Um ligeiro aumento da razão de (0 0 2) a (1 0 1) pico é observado com o aumento de O 2 tempo de plasma (mostrado no arquivo adicional 1:Figura S1). Isso sugere um maior grau de orientação preferencial quando exposto a um plasma mais longo. Comportamento semelhante também foi relatado [27, 28]. No entanto, vale ressaltar que a mudança da razão de intensidade em nosso trabalho é bastante trivial em comparação com outros. Isso sugere ainda mais a estabilidade de nosso processo ALD superciclado para a produção de filmes de ZnO de alta qualidade. Os tamanhos médios de grão também foram estimados com base na fórmula de Scherrer [29] e foram encontrados para ser ca. 11 nm, sugerindo que o tamanho do grão de ZnO quase não foi afetado pelo O 2 tempo de plasma. Padrões semelhantes também são observados em filmes de ZnO crescidos a partir de vários ciclos ALD térmicos ( m ) com um O 2 fixo tempo de plasma (1 s), conforme mostrado na Fig. 2b.
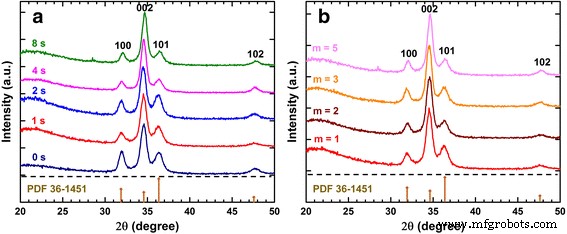
Padrões de XRD de filmes de ZnO crescidos pelo processo ALD superciclado usando a diferente O 2 tempos de plasma com ciclo térmico fixo ( m =1) e b diferentes ciclos térmicos com O 2 fixo tempo de plasma ( t 3 =1 s)
Além da cristalinidade, as propriedades ópticas dos filmes de ZnO crescidos em ALD superciclado também foram estudadas usando elipsometria espectroscópica (SE). Constantes ópticas ( n e k ) podem ser extraídos dos resultados da elipsometria por um modelo Tauc-Lorentz que é comumente usado no ajuste de filmes de ZnO [28, 30, 31]. Semelhante à cristalinidade análoga, as propriedades ópticas dos filmes de ZnO depositados com diferentes O 2 os tempos de plasma e os ciclos térmicos também permanecem inalterados, conforme mostrado no arquivo adicional 1:Figura S2. Isso é consistente com os trabalhos relatados de que uma mudança na cristalinidade está sempre associada a uma mudança nas propriedades ópticas [28, 32]. As propriedades morfológicas dos filmes de ZnO são caracterizadas por AFM. Todos os filmes foram considerados igualmente lisos, com rugosidade média entre ca. 0,3 e 0,8 nm (arquivo adicional 1:Figura S3).
As propriedades elétricas dos filmes de ZnO crescidos pelo processo ALD superciclado são investigadas por um sistema de efeito Hall. Todos os filmes foram considerados n -tipo semicondutor, e a resistividade aumenta de ca. 10 −3 a 10 3 Ω cm com aumento de O 2 tempo de plasma e ciclo térmico fixo ( m =1) como mostrado na Fig. 3a. Isso está associado à redução da concentração de transportadores de ca. 10 21 a 10 15 cm −3 como o O 2 o tempo de plasma aumenta de 0 a 8 s (Fig. 3b). Ao contrário, as mobilidades eletrônicas de todos os filmes de ZnO são bastante consistentes (ca. 3,0 ± 1,0 cm 2 / V s) e não são afetados pela duração do plasma. O mecanismo de condução detalhado será abordado mais adiante na seção abaixo. Em comparação com o processo ALD intensificado por plasma que relatamos anteriormente [21], a magnitude do ajuste de resistividade foi melhorada ainda mais no processo ALD superciclado para mais de cinco ordens. Além disso, este processo ALD proposto oferece um controle mais refinado sobre essas propriedades elétricas, variando o ciclo térmico ( m ) em um superciclo enquanto conserta o O 2 tempo de plasma ( t 3 ) Isso é particularmente útil no caso de t 3 =1 s onde o ajuste não é alcançável reduzindo ainda mais o tempo de plasma devido à limitação do equipamento ALD. Os pontos abertos na Fig. 3a, b representam as resistividades e as concentrações de portadores de filmes de ZnO crescidos por diferentes ciclos térmicos ( m =2, 3, 5) quando t 3 =1 s (as barras de erro estão entre os pontos). Pode-se observar que mais ciclos térmicos resultam em filmes menos resistivos com maiores concentrações de portadores. Isso fornece um extra de três resistividades dentro da faixa de 10 −3 a 10 1 Ω cm.
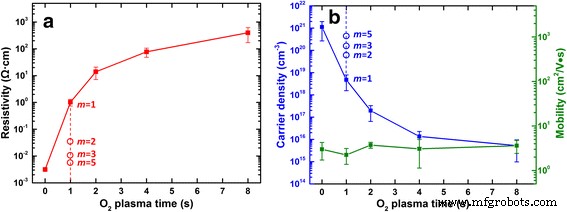
a Resistividade elétrica de filmes de ZnO crescidos de diferentes O 2 tempos de plasma com ciclo térmico fixo m (pontos sólidos) e diferentes ciclos térmicos com O 2 fixo tempo de plasma (pontos abertos) pelo processo ALD superciclado. b Concentração de portador (azul) de filmes de ZnO cultivados a partir de diferentes O 2 tempos de plasma com ciclo térmico fixo (pontos sólidos) e diferentes ciclos térmicos com O 2 fixo tempo de plasma (pontos abertos). Mobilidade (verde) de filmes ZnO crescidos a partir de diferentes O 2 tempos de plasma com um ciclo térmico fixo
As medições KPFM foram realizadas para obter insights sobre as posições de nível de Fermi dos filmes de ZnO com a resistividade em mudança. Ele mede a diferença de potencial de contato V CPD entre uma ponta condutora e a amostra, que é definida como:
$$ {V} _ {\ mathrm {CPD}} =\ frac {\ phi _ {\ mathrm {tip}} - {\ phi} _ {\ mathrm {amostra}}} {q} $$ (1)
onde q é a cobrança eletrônica, enquanto ϕ dica e ϕ amostra são a função de trabalho da ponta e da amostra, respectivamente. Quando dois materiais diferentes são colocados em contato elétrico, os níveis de Fermi se alinham por meio do fluxo de corrente de elétrons que, consequentemente, induz uma diferença de potencial de contato entre a ponta e a amostra, conforme mostrado no Arquivo adicional 1:Figura S4. O princípio de funcionamento detalhado do KPFM é apresentado no arquivo adicional 1. As diferenças de potencial de contato dos filmes de ZnO crescidos pelo processo ALD superciclado de diferentes O 2 tempos de plasma com ciclo térmico fixo ( m =1) são mostrados na Fig. 4. Enquanto cada V CPD a imagem parece ser uniforme e relativamente lisa, diferenças substanciais na média V CPD os valores podem ser observados (mostrado na Fig. 4f). A função de trabalho da ponta ϕ dica permanece constante para todas as medições; a diferença substancial em V CPD é, portanto, a consequência da mudança de nível de Fermi em diferentes filmes ZnO. Uma mudança total de ca. 0,32 eV é obtido entre o filme de ZnO crescido com 0 e 8 s O 2 tempo de plasma que é significativo em comparação com o bandgap de ZnO (ca. 3,22 eV com base nos resultados de SE neste trabalho, conforme mostrado no arquivo adicional 1:Figura S2c). Para filmes de ZnO cultivados a partir de diferentes ciclos térmicos ( m =2, 3, 5) em O 2 fixo tempo de plasma ( t 3 =1 s), diferente V CPD valores também foram detectados como mostrado na Fig. 4f. As imagens KPFM bidimensionais desses filmes podem ser encontradas no Arquivo Adicional 1:Figura S5. Isso implica que a mudança no equilíbrio elétron-buraco ocorre ao longo dos filmes, o que poderia causar um impacto considerável na concentração do portador de ZnO.
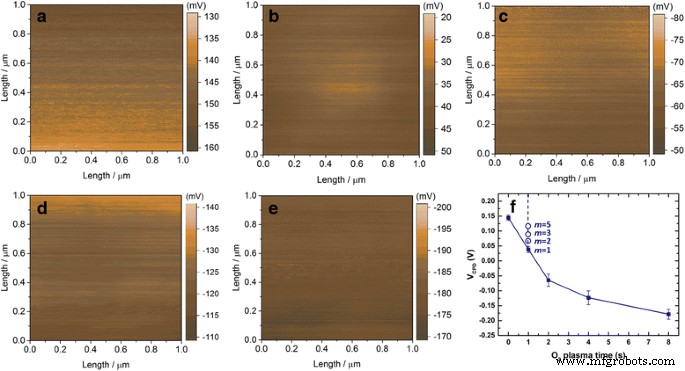
a - e Diferença de potencial de contato bidimensional V CPD imagens das medições de potencial de superfície dos filmes de ZnO crescidos em ALD superciclados com O 2 tempo de plasma ( t 3 ) variando de 0 a 8 se ciclo térmico fixo ( m =1). f Média V CPD valores com variação de O 2 tempos de plasma (pontos sólidos) e ciclos térmicos (pontos abertos)
Para investigar a relação entre o nível de Fermi e a concentração de portadores, adotamos o modelo eletrônico de energia proposto por Maragliano et al. para correlacionar a diferença de potencial de contato V CPD com a concentração de dopagem no material [26]. Assumindo a concentração efetiva de doadores n D é significativamente maior do que a concentração intrínseca de transportador, pode ser escrito como:
$$ {n} _ {\ mathrm {D}} \ aprox {N} _ {\ mathrm {C}} \ exp \ left (\ frac {q {V} _ {\ mathrm {C} \ mathrm {PD} } - {\ phi} _ {\ mathrm {tip}} + \ chi} {K_BT} \ right) $$ (2)
onde N C é a densidade efetiva de estados, χ é a afinidade eletrônica do semicondutor, K B é a constante de Boltzmann, e T é a temperatura. Embora os valores da densidade efetiva dos estados N C , a função de trabalho da ponta ϕ dica , e a afinidade do elétron χ são difíceis de obter, as diferenças relativas de concentração de portadores de diferentes filmes de ZnO podem ser calculadas, pois esses valores são os mesmos em todas as medições. Conseqüentemente, a razão de concentração de transportador entre os filmes crescidos com 0 s de O 2 o tempo de plasma para um determinado filme de ZnO pode ser expresso como:
$$ \ frac {n_0} {n_x} =\ exp \ left (\ frac {V _ {\ mathrm {CPD} 0} - {V} _ {\ mathrm {CPD} x}} {K_BT / q} \ right) $$ (3)
em que n 0 e n x são a concentração de portadores do filme de ZnO crescido com 0 e x s de O 2 tempo de plasma, respectivamente, e V CPD0 e V CPD x são as diferenças de potencial de contato correspondentes. As razões de concentração de transportadores calculadas são representadas graficamente na Fig. 5 como uma função de O 2 tempo de plasma. A razão de concentração é calculada para aumentar com O 2 mais longo tempo de plasma (vermelho). Mais importante ainda, a tendência de aumento corresponde bem aos valores obtidos a partir dos resultados da medição do efeito Hall (preto). Tendência semelhante também foi observada para filmes de ZnO crescidos a partir de diferentes ciclos térmicos ( m =2, 3, 5) em O 2 fixo tempo de plasma ( t 3 =1 s). Isso evidentemente sugere que a mudança do nível de Fermi do filme de ZnO está diretamente associada ao nível de concentração do portador.
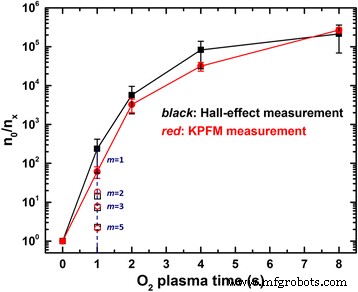
Efeito Hall e resultados de medição KPFM das razões de concentração de transportadores entre filmes de ZnO cultivados com variação de O 2 tempos de plasma (pontos sólidos) e ciclos térmicos (pontos abertos)
Medições de espectroscopia de fotoelétrons de raios-X (XPS) foram realizadas para lançar luz sobre o mecanismo de condução estudando a ligação e os estados químicos dos filmes de ZnO crescidos em ALD superciclados. Os estados químicos de O 1 s são mostrados na Fig. 6, onde dois picos podem ser identificados após os ajustes de Gauss. O pico de energia inferior (A) posicionado ca. 530.3 eV é sugerido como o O 2− íons na estrutura wurtzita do Zn hexagonal 2+ íons [33,34,35]. As atribuições do componente de energia de ligação mais alto em ca. 532,2 (B) têm sido controversos sobre a literatura [33,34,35,36,37,38]. No entanto, é amplamente relatado que está associado ao grupo hidroxila (ou seja, Zn-OH) [33, 37,38,39] no filme de ZnO. Portanto, atribuímos provisoriamente o O B pico observado na Fig. 6 às ligações Zn-OH. Por outro lado, o pico associado à vacância de oxigênio posicionado em ca. 531,2 eV [35] não é observado neste trabalho. Filme de ZnO crescido pelo processo ALD térmico ( t 3 =0 s) caracteriza um O B dominante pico no espectro XPS (Fig. 6a). Isso implica na existência de grande quantidade de impurezas relacionadas ao hidrogênio neste filme. Este alto nível de defeitos serve como um mecanismo de autodopagem e leva a uma alta concentração de portadores. O extra O 2 etapa de plasma ( t 3 ) diminui as impurezas, e o O B a intensidade do pico diminui com O 2 mais longo tempo de plasma (Fig. 6f). Tendência semelhante também foi observada para filmes de ZnO crescidos a partir de vários ciclos térmicos nos quais mais ciclos térmicos levam ao aumento de O B intensidade de pico como mostrado na Fig. 6f e arquivo adicional 1:Figura S6.

a - e Espectros XPS e seus ajustes gaussianos dos O 1 s região dos filmes de ZnO crescidos em ALD superciclados com O 2 tempo de plasma ( t 3 ) variando de 0 a 8 se ciclo térmico fixo ( m =1). f Proporção do O B relacionado ao hidrogênio pico em filmes de ZnO crescidos com variação de O 2 tempos de plasma (pontos sólidos) e ciclos térmicos (pontos abertos)
A origem do intrínseco n A condutividade do tipo em filmes ZnO ainda é controversa. Embora a sabedoria convencional tenha atribuído essa condutividade ao defeito nativo (ou seja, vacâncias de oxigênio e intersticiais de Zn) [18, 40,41,42,43,44], ela foi contestada por cálculos recentes de primeiros princípios [45]. As vacâncias de oxigênio também não devem contribuir para um nível de concentração tão alto, já que vários estudos sugerem que elas são profundas ao invés de doadoras superficiais e têm altas energias de formação em n -tipo ZnO (e, portanto, não têm forma semelhante) [41,42,43,44]. Além disso, o O 1 s relacionado à vacância de oxigênio o pico também não é observado em nossos dados XPS mostrados na Fig. 6. Embora os intersticiais Zn sejam doadores superficiais, foi sugerido que eles têm altas energias de formação e são difusores mais rápidos e, portanto, é improvável que sejam estáveis [41]. Os espectros XPS do Zn 2 p 3/2 estado dos filmes ZnO crescidos em ALD superciclados com vários O 2 os tempos de plasma são mostrados na Fig. 7. Todos os espectros são caracterizados por um pico semelhante posicionado em ca. 1021,5 eV que pode ser atribuído ao Zn 2+ ligação em ZnO [6, 34, 46]. No entanto, o componente intersticial Zn em uma energia de ligação ligeiramente superior [6, 47] não é observado em todos os espectros. Isso sugere que a influência do intersticial Zn na condutividade do filme de ZnO também pode ser descartada neste trabalho.

a - e Espectros XPS e seus ajustes gaussianos do Zn 2 p 3/2 região dos filmes de ZnO crescidos em ALD superciclados com O 2 tempo de plasma ( t 3 ) variando de 0 a 8 se ciclo térmico fixo ( m =1)
Recentemente, impurezas / defeitos relacionados ao hidrogênio são propostos para desempenhar um papel no n -tipo de condutividade em ZnO [33, 48]. A evidência da existência de ligações de hidrogênio no ZnO foi demonstrada por Janotti et al. [48], e tem sido sugerido que essas ligações são capazes de se incorporar em altas concentrações e se comportar como doadores superficiais [49,50,51]. Na verdade, o hidrogênio está presente em nosso processo ALD superciclado como precursor e H 2 O contém hidrogênio e uma ligação Zn-OH é produzida a cada meio ciclo na etapa ALD térmica. Isso também é apoiado pela observação de O 1 s relacionado ao grupo hidroxila pico no espectro de XPS (mostrado na Fig. 6). A resistividade do filme de ZnO e a densidade do portador são representadas graficamente contra a proporção desse pico na Fig. 8. A alta proporção dessas impurezas de hidrogênio induz altas concentrações de portador, levando a baixas resistividades. O subsequente O 2 a etapa de plasma dentro de cada superciclo reduz a concentração de portadores, removendo efetivamente as ligações de hidrogênio. Isso é acompanhado pela redução da concentração de portadores, bem como pelo aumento da resistividade. O mesmo comportamento também foi relatado em processos ALD e CVD [33, 52].
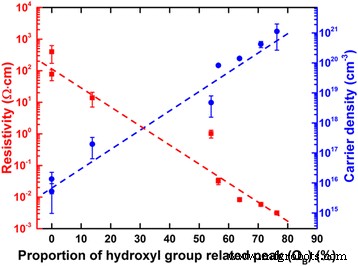
Resistividade elétrica e concentração de portadores em função do O B relacionado ao grupo hidroxila proporção de pico (linhas tracejadas são guias do olho)
Conclusões
A deposição de filmes de ZnO não dopados com propriedades elétricas altamente ajustáveis foi relatada aqui usando um processo ALD superciclado que combina um processo ALD térmico e O 2 in situ tratamento com plasma. Mais de cinco ordens de ajuste de magnitude sobre a resistividade do filme e concentração de portadores foram alcançados ajustando o O 2 tempos de plasma. O ajuste mais fino das propriedades também pode ser realizado variando o número de ciclos ALD térmicos em um superciclo. Acredita-se que o ajuste dessas propriedades elétricas esteja associado à mudança na concentração do defeito do hidrogênio no filme. Isso causa diretamente a mudança dos níveis de Fermi dentro dos filmes de ZnO, conforme revelado pela microscopia de força de sonda Kelvin. Ao adotar um modelo de energia eletrônico simples, as concentrações de portadores calculadas a partir das mudanças de nível de Fermi demonstram uma boa correspondência com os resultados da medição do efeito Hall. Esta técnica confiável e robusta relatada aqui aponta claramente para a capacidade de usar este método para produzir filmes de ZnO com propriedades controladas em diferentes aplicações.
Abreviações
- ALD:
-
Deposição de camada atômica
- DEZ:
-
Dietilzinco
- KPFM:
-
Microscopia de força de sonda Kelvin
- XPS:
-
espectroscopia de fotoelétrons de raios-X
- XRD:
-
Difração de raios X
Nanomateriais
- Tecnologias de Deposição de Camada Atômica Avançada para Micro-LEDs e VCSELs
- Características de chaveamento resistivo bipolar de dispositivos RRAM de estrutura tricamada de HfO2 / TiO2 / HfO2 em substratos revestidos com Pt e TiN fabricados por deposição de camada atômica
- Características interfaciais, elétricas e de alinhamento de banda de pilhas de HfO2 / Ge com camada intermediária de SiO2 formada in situ por deposição de camada atômica aprimorada com plasma
- As Nanofibras Hierárquicas de Poliamida 6-ZnO Antibacteriana Fabricadas por Deposição de Camada Atômica e Crescimento Hidrotérmico
- Propriedades fotocatalíticas de pós de TiO2 revestidos com Co3O4 preparados por deposição de camada atômica aprimorada com plasma
- Deposição em duas etapas de ZnO dopado com Al em p-GaN para formar contatos ôhmicos
- Ajustando as morfologias de superfície e propriedades dos filmes ZnO pelo projeto da camada interfacial
- Propriedades ópticas de filmes ZnO com dopagem Al-Dopada na região infravermelha e suas aplicações de absorção
- Efeito de diferentes morfologias CH3NH3PbI3 nas propriedades fotovoltaicas de células solares de perovskita
- Propriedades de preparação e antibiofilme de filmes compostos de óxido de zinco / alumina anódica porosa



