Dosagem conjunta de ozônio e água desionizada como precursores oxidantes do crescimento de película fina de ZnO por deposição de camada atômica
Resumo
Características de deposição de camada atômica (ALD) - filmes finos de ZnO crescidos em substratos de safira com e sem ozônio de três pulsos (O 3 ) como precursor de oxidante e recozimento térmico pós-deposição (TA) são investigados. A temperatura de deposição e a espessura das epilayers de ZnO são 180 ° C e 85 nm, respectivamente. O recozimento térmico pós-deposição é conduzido a 300 ° C no ambiente de oxigênio (O 2 ) por 1 h. Com forte agente oxidante O 3 e TA pós-deposição em crescimento de ZnO, tensão intrínseca e estresse são reduzidos a 0,49% e 2,22 GPa, respectivamente, com concentração de elétrons de fundo extremamente baixa (9,4 × 10 15 cm −3 ) Este é originado de uma menor densidade de defeitos ativados termicamente nas análises de extinção térmica dos espectros de intensidade integrada de fotoluminescência (PL). TA facilita ainda mais a recristalização formando mais grãos sem defeitos e, em seguida, reduz a tensão e o estado de estresse, causando uma diminuição notável da concentração de elétrons e melhora da rugosidade da superfície.
Introdução
Vários agentes oxidantes são usados no crescimento de ZnO. Eles incluem água (H 2 O), peróxido de hidrogênio (H 2 O 2 ), oxigênio (O 2 ) e ozônio (O 3 ) [1,2,3,4,5,6]. H 2 O é um oxidante comumente usado no crescimento de ZnO com deposição de camada atômica (ALD). ALD é um mecanismo de crescimento autolimitante camada por camada. Reações de troca de ligantes de superfície específicos com pulsação sequencial dos respectivos precursores. As reações de superfície param e saturam quando os locais reativos da superfície estão completamente esgotados. O crescimento ALD de filmes finos tem vantagens como deposição conformada superior em superfícies e regiões laterais, excelente cobertura de degraus de bordas, alta uniformidade em uma grande área, precisão no controle de espessura de camada e adequado para baixa temperatura de deposição [7,8,9] .
Os agentes oxidantes fortes influenciam não apenas as estruturas do material, mas também as características optoelétricas do ZnO depositado em ALD. H 2 O 2 oxidante fornece condições mais ricas em oxigênio do que o comumente usado H 2 O precursor para passivar defeitos de vacâncias de oxigênio (V O ) e intersticiais de zinco (Zn i ) em filmes de ZnO crescidos com ALD em baixas temperaturas de crescimento de 80 a 150 ° C. Morfologias de superfície colunar com (002) orientação preferencial de plano de crescimento ocorreram quando o uso de oxidante é alterado de H 2 O a H 2 O 2 [2]. H 2 O 2 o oxidante aumenta as taxas de crescimento em aproximadamente 70% em comparação com o uso de O 3 reagente de gás de ZnO crescido em ALD a 200 ° C. O aumento da densidade do grupo hidroxila (OH) na superfície de crescimento dos filmes é responsável pelo aumento das taxas de crescimento [3]. O aumento da taxa de crescimento de ZnO cerca de 60% para o uso de O 2 puro em vez de H 2 O como um oxidante também é relatado [4].
O 3 é um oxidante eficaz em materiais óxidos crescidos com ALD. O alto potencial eletroquímico de O 3 dá origem a taxas de reação rápidas a uma temperatura de crescimento baixa. O 3 é mais volátil do que H 2 O, H 2 O 2 , e O 2 , e é mais fácil de limpar. Portanto, os tempos de purga em cada ciclo podem ser reduzidos. A ausência de hidrogênio em O 3 molécula leva a menos contaminação de hidrogênio e hidroxila no crescimento. Menos uniforme em espessura devido à perda de superfície recombinante de ZnO é mostrado para 10 s de O 3 tempos de exposição quando o crescimento está a 200 ° C [5]. Filmes de ZnO não dopados preparados por ALD com O 3 agentes oxidantes mostram um fator de potência termoelétrica duplo em comparação com amostras com H 2 O oxidante. H 2 O- e O 3 Filmes ZnO crescidos têm os mesmos níveis de defeito de V O mas diferentes níveis de defeito relacionados ao Zn. Poder de oxidação suficiente do O 3 resulta em um conteúdo inferior de Zn nativo i e, portanto, um fator de potência termoelétrica maior. Forte efeito oxidante de O 3 eleva o desempenho termoelétrico de filmes de ZnO não dopados [6]. Co-dosagem O 3 e H 2 O pode melhorar a uniformidade e conformalidade do filme fino de ZnO para processos ALD adequados [5].
Cepas intrínsecas e extrínsecas existem no filme de ZnO cultivado em um substrato de safira naturalmente. A cepa intrínseca é originada de imperfeições cristalográficas de alta densidade no ZnO. As imperfeições cristalográficas incluem complexos de hidrogênio, intersticiais de zinco (Zn i ), vagas de oxigênio (V O ), deslocamentos de rosca (TDs) e limites de grão (GBs) [10,11,12,13,14,15,16,17,18,19,20,21]. A tensão extrínseca é gerada a partir de uma grande incompatibilidade de constantes de rede e coeficientes de expansão térmica entre a camada de epilação de ZnO e o substrato de safira. Várias maneiras são exercidas para diminuir a deformação intrínseca e extrínseca dos materiais ZnO nas safiras. A camada fina de tampão de MgO pode diminuir a tensão extrínseca, reduzir a rugosidade da superfície em 58,8% e suprimir as rachaduras superficiais do filme fino de ZnO na safira [22]. A cepa extrínseca de ZnO na safira é totalmente relaxada com a espessura atingindo 30 nm preparada por deposição catódica de magnetron a 550 ° C [23]. O relaxamento da tensão compressiva de 1,77 a 1,47 GPa de filmes de ZnO depositados pelo método de spray pyrolysis com o aumento da temperatura do substrato de vidro de 350 a 450 ° C é exibido [24].
ALD ZnO cultivado a 180 ° C com precursores de um pulso (DEZn e H 2 O) mostra a concentração de elétrons de fundo tão alta quanto ~ 10 18 cm −3 mesmo com TA pós-deposição [25]. Comumente usado H 2 de um pulso Os precursores dos processos ALD não geram a monocamada ideal de átomos de oxigênio. Precursores de três pulsos (DEZn e H 2 O) poderia gerar múltiplos acertos ou colisões de moléculas precursoras com ligante de superfície para promover a probabilidade de reação para ALD ZnO cultivado em baixa temperatura de 100 ° C. A escolha de “três” pulsos ajuda a garantir que os reagentes localizem a quimissorção aberta ou o local de reação de maneira adequada. Concentração de elétrons de fundo extremamente baixa 8,4 × 10 14 cm −3 , alta mobilidade de deriva de elétrons 62,1 cm 2 / Vs, e o realce pronunciado da próxima borda do bandgap (NBE) fotoluminescência (PL) de precursores de três pulsos ZnO com camada tampão adequada e condições RTA são adquiridos [26]. Vários relatórios mostram o aprimoramento da qualidade do material de filmes finos de ZnO e poços quânticos múltiplos de ZnO / ZnMgO com recozimento térmico [27, 28]. Neste relatório, O 3 de três pulsos e subsequente H 2 de um pulso O como oxidantes por ciclo ALD são usados para fazer crescer filmes finos de ZnO a 180 ° C. O recozimento térmico pós-deposição (TA) é aplicado para melhorar a qualidade cristalina das amostras. São exploradas as características do material micro e nanoestrutural, fotoluminescência e efeito Hall de filmes finos de ZnO crescidos em ALD.
Métodos Experimentais
As epilayers de ZnO são depositadas em safira c-face convencional (c-Al 2 O 3 ) substratos pelo sistema Cambridge NanoTech Savannah 100 ALD. No crescimento de filmes finos ALD ZnO, precursores, incluindo desionizado (DI) H 2 O, O 3 e dietil zinco (DEZn, Zn (C 2 H 5 ) 2 ) são utilizados. A Tabela 1 demonstra as condições do número de pulso de O 3 e TA pós-deposição de três espécimes denominados A, B e C. Um diagrama esquemático da sequência de pulso com tempo por ciclo ALD de amostras é exibido na Fig. 1. Nesta figura, um ciclo ALD contém seis etapas sequenciais. A primeira etapa é a injeção de H desionizado de um pulso (DI) 2 O em um reator em escala de metros para fazer uma superfície terminada em hidroxila (OH) na safira ou para reagir com os grupos etila pendentes (C 2 H 5 ) formando pontes de zinco-oxigênio (Zn – O) na superfície de Zn com grupos de superfície hidroxila. Uma camada atômica de oxigênio (O) é produzida. A segunda etapa é a purga do gás nitrogênio de alta pureza (N 2 ) para remover o excesso de moléculas precursoras e subprodutos voláteis e para evitar a mistura de precursores subsequentes após cada exposição de reagentes. A terceira etapa é a injeção de três pulsos O 3 em reatores para facilitar a redução de defeitos nativos. A quarta etapa é a purga da câmara por N 2 gás. A quinta etapa é a injeção de DEZn de um pulso em reatores para produzir uma camada atômica de zinco (Zn) sobre a camada de oxigênio. A etapa final também é a purga da câmara por N 2 gás. Os precursores pulsaram na câmara de reação através do gás de transporte N 2 com uma pressão da câmara de 4 × 10 −1 Torr. A condição ideal de tempo de exposição para os reagentes DI H 2 O, O 3 e DEZn é 0,01, 0,5 e 0,015 s, respectivamente. O tempo de pulso de evacuação da câmara é de 5 s. A espessura dos filmes finos de ZnO é de 85 nm com 500 ciclos ALD de cada amostra. Outras condições favoráveis de parâmetros de deposição são apresentadas nos relatórios anteriores [29]. Pós-deposição TA a 300 ° C no ambiente de O 2 por 1 h em um forno é processado na amostra C.
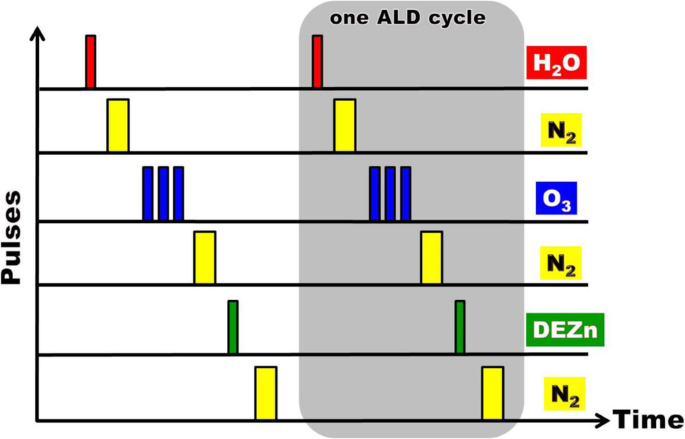
Filmes de ZnO crescidos em ALD em substratos de safira com sequência de pulso H 2 O / N 2 / O 3 / N 2 / DEZn / N 2 usando água DI, O 3 e Zn (C 2 H 5 ) 2 como os precursores
As propriedades estruturais, ópticas e elétricas do material de amostras são conduzidas pelas seguintes medições. Os padrões de difração de raios-X (XRD) são medidos com ângulo de difração (2 θ ) faixa de 33 a 38 ° e comprimento de onda de 0,154 nm de radiação Kα de cobre usando o instrumento D2 phaser (Bruker Corporation). A medição do efeito Hall usa o sistema Ecopia HMS-3000 e os espécimes são cortados em quadrados com uma área de tamanho de 0,7 × 0,7 cm 2 . Quatro cantos dos espécimes são soldados por pequenas bolhas de índio mostrando contatos ôhmicos na configuração de van der Pauw. A densidade do portador da folha, a mobilidade e a resistividade dos filmes são medidas. Os espectros de fotoluminescência (PL) são realizados de 10 a 300 K com um comprimento de onda de excitação de 325 nm e uma potência de 55 mW do laser He-Cd. A extinção térmica de intensidade integrada de espectros PL com o aumento da temperatura é analisada. A textura e aspereza da superfície dos espécimes examinadas em imagens de alta resolução do microscópio de força atômica (AFM) são obtidas pelo instrumento do Veeco Dimension 3100.
Resultados e discussão
A Figura 2 demonstra a natureza cristalina das amostras pelas medições dos padrões de XRD. Dois picos de difração de Bragg (002) e (101) correspondem à estrutura wurtzita hexagonal do ZnO. A intensidade de pico mais forte dos padrões de XRD é normalizada para comparação da intensidade de pico entre as amostras. Duas setas verdes indicadas no eixo horizontal superior mostram ângulos de difração de 34,4 ° e 36,2 ° de (002) e (101), respectivamente, de ZnO em massa livre de deformação adquirido dos conjuntos de dados de material divulgados pela organização do Joint Committee on Powder Diffraction Padrões (JCPDS). Na figura, pode-se observar os picos (002) e (101) na abordagem da amostra B e C e abordagem adicional dos ângulos de difração de (002) e (101) do ZnO bruto livre de deformação.

Padrões de XRD de filmes de ZnO com orientações cristalinas ao longo das direções (002) e (101) dos espécimes. As setas indicam os ângulos de difração de 34,4 ° e 36,2 ° de (002) e (101) do ZnO em massa, respectivamente
Deformação biaxial ao longo do c O eixo das camadas epitaxiais pode ser obtido por meio do deslocamento dos padrões de XRD ao longo de (002) em contraste com o ZnO em massa livre de deformação. Tensão média ( ε z ) na rede de filmes de ZnO é estimado a partir dos parâmetros da rede usando a seguinte expressão.
$$ {\ varepsilon} _z =\ frac {c- {c} _0} {c_0} \ times 100 \% $$ (1)
onde c e c 0 são as constantes de rede ao longo do c -eixo calculado a partir dos ângulos de difração de Bragg de (002) picos de filmes de ZnO e volume. A tensão média ( σ ) no plano dos filmes pode ser calculado usando o modelo de deformação biaxial:
\ (\ sigma =\ frac {2 {c} _ {13} ^ 2- {c} _ {33} \ left ({c} _ {11} + {c} _ {12} \ right)} {c_ {13}} \ times {\ varepsilon} _z =-453.6 \ times {\ varepsilon} _z \ left (\ mathrm {GPa} \ right) \) (2) onde c 11 =209,7 GPa, c 12 =121,1 GPa, c 13 =105,1 GPa e c 33 =210,9 GPa são as constantes de rigidez elástica do ZnO em massa. Na Tabela 1, as deformações / tensões ( ε z / σ ) das amostras A, B e C são 1,08% / 4,90 GPa, 0,74% / 3,37 GPa e 0,49% / 2,22 GPa, respectivamente. A deformação / estresse é reduzido e ainda mais reduzido nas amostras B e C.
Espectros PL em várias temperaturas de 10 a 300 K de amostras são exibidos na Fig. 3. Forte recombinação radiativa perto da borda da banda de excitons com energia de pico espectral em torno de 3,34 eV é dominante nos espectros PL de todas as amostras. A emissão óptica assistida por fônon óptica longitudinal (LO) é observada no ombro de energia inferior dos espectros PL das amostras. Na Fig. 4a-c, ele exibe o gráfico de Arrhenius da intensidade integrada dos espectros PL versus o inverso da temperatura. A extinção térmica de intensidade integrada de PL com o aumento da temperatura pode ser ajustada pela seguinte fórmula de Arrhenius.
$$ I (T) =\ frac {A} {1+ {D} _ {nr1} \ exp \ left (\ frac {- {E} _ {A1}} {k _ {\ mathrm {B}} T} \ right) + {D} _ {nr2} \ exp \ left (\ frac {- {E} _ {A2}} {k _ {\ mathrm {B}} T} \ right)} $$ (3)
onde eu ( T ) representa a intensidade PL integrada. A é uma constante. D nr 1 e D nr 2 são constantes relacionadas à densidade dos centros de recombinação não radiativa. E A 1 e E A 2 são as energias de ativação correspondentes ao processo de recombinação não radiativa de excitons ligados do doador em baixa temperatura e excitons livres em alta temperatura, respectivamente. k B é a constante de Boltzmann. O método dos mínimos quadrados na análise de regressão é utilizado para ajustar os dados que mostram os parâmetros de D nr 1 , D nr 2 , E A 1 , e E A 2 com curvas de ajuste vermelhas na Tabela 2 e Fig. 4a – c. O resultado do ajuste mostra que variações de D nr 1 , E A 1 , e E A 2 entre as amostras são leves. D nr 2 são 132,7, 153,6 e 110,8 das amostras A, B e C, respectivamente, mostrando uma grande diferença na quantidade de densidade de defeito. O menor valor de D nr 2 sugere a menor densidade de defeitos ativados termicamente na amostra C.
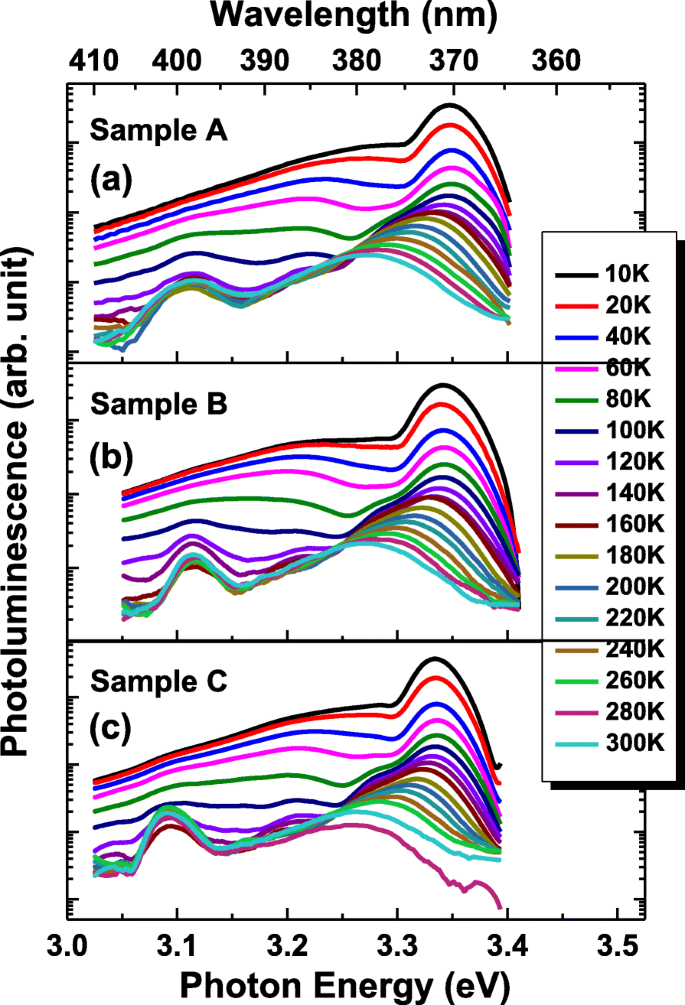
a - c Espectros de espécimes PL dependentes da temperatura
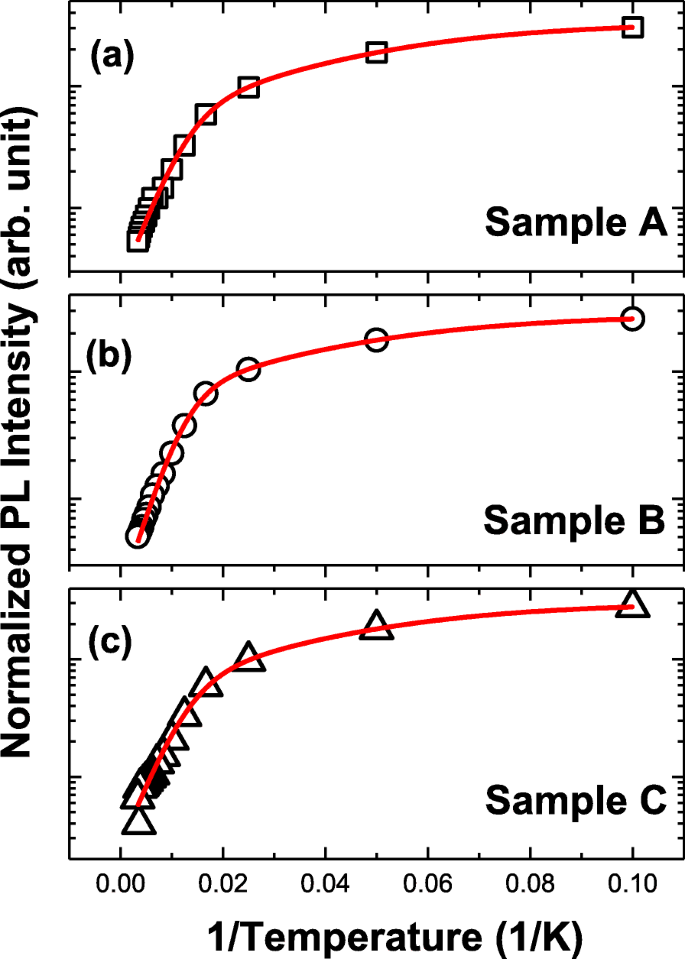
a - c Gráficos de Arrhenius de extinção térmica de intensidade integrada de espectros PL e curvas de ajuste vermelho de amostras
A concentração de elétrons de fundo, mobilidade e resistividade das medições de efeito Hall das amostras estão listadas na Tabela 2. Na amostra B, duas ordens de diminuição de magnitude da concentração de portadores com redução de mobilidade são mostradas em comparação com a amostra A. para o menor valor de 9,4 × 10 15 cm −3 e o aumento da mobilidade para um valor de 6,1 cm 2 / Vs são observados na amostra C em comparação com a amostra B. A menor quantidade de concentração de elétrons é devido ao maior relaxamento dos estados de tensão / tensão e redução notável da densidade de defeito nativo na amostra C.
As Figuras 5a – c e d – f são imagens AFM 2D e 3D de espécimes. A rugosidade quadrada média (RMS) de A, B e C é 1,92, 4,30 e 2,18 nm, respectivamente, conforme mostrado na Tabela 2. A rugosidade de textura superficial mais baixa ocorreu na amostra A. Com o uso de O 3 precursor na amostra B, a rugosidade da superfície é aumentada. A redução da uniformidade espacial dos filmes ALD ZnO é devido à perda de superfície de O 3 [21]. Perda de superfície de O 3 está relacionado à transição de crescimento limitado por reação para recombinação e pode constituir o canal de perda atômica primário para destruir os filmes, resultando em uma uniformidade de espessura pobre. Isso está correlacionado à redução da intensidade do pico de difração ao longo de (002) na amostra B na Fig. 2. Com o tratamento de TA pós-deposição na amostra C, a uniformidade da superfície é melhorada. Enquanto isso, uma diminuição dramática da concentração de elétrons de fundo e um aumento da mobilidade são alcançados. O recozimento térmico provoca a migração na estrutura do cristal; assim, ocorre a recristalização metalúrgica. A recristalização acompanha a redução da resistência de deformação / tensão e imperfeições da rede cristalina intrínseca; portanto, obtém-se uma melhor qualidade de filme fino de ZnO. Este resultado é consistente com o aumento de duas intensidades de pico de difração no padrão de XRD na amostra C. É importante notar que a mobilidade dos elétrons pode ser afetada por fontes de espalhamento, como impurezas, redes e defeitos. Essas fontes de espalhamento podem alterar a velocidade média do elétron. Em geral, a redução da densidade do defeito e, portanto, a diminuição da concentração de elétrons levam ao aumento da mobilidade. Neste relatório, um aumento da rugosidade da textura da superfície devido à ação do precursor de ozônio de dosagem pode causar menor mobilidade de elétrons na amostra C do que A. Na Fig. 6, um diagrama de pirâmide contendo três triângulos em cores diferentes ilustra o crescimento de três chaves e condições de processamento para alcançar epilayers ALD ZnO de alta qualidade neste relatório.
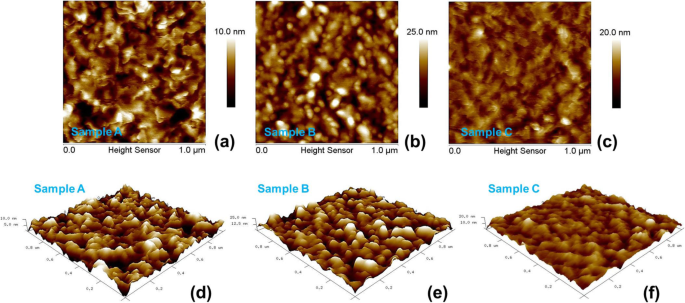
a - c 2D e d - f Imagens 3D AFM de espécimes. A escala de altura em imagens 2D é apresentada na barra de cores à direita

Um diagrama de pirâmide. Na pirâmide, quatro triângulos são ilustrados em cores diferentes. Três triângulos nas bordas da pirâmide mostram as principais condições de crescimento e processamento do ZnO. A combinação desses três componentes cruciais no crescimento promove a qualidade das camadas de epilação ALD ZnO mostradas pelo triângulo no centro da pirâmide
Conclusões
H 2 de um pulso O e oxidante forte de três pulsos O 3 precursores nos processos ALD podem diminuir a deformação / estresse e, portanto, reduzir visivelmente a concentração de elétrons no filme fino de ZnO, mas aumentar a rugosidade da superfície. Pós-deposição TA a 300 ° C no ambiente de oxigênio (O 2 ) por 1 h pode facilitar ainda mais a formação de mais grãos livres de defeitos com menor deformação / estresse, menor concentração de elétrons de fundo e melhora da rugosidade da superfície após o crescimento usando O 3 de três pulsos precursores. A menor tensão / estresse e concentração de elétrons de fundo que são 0,49% / 2,22 GPa e 9,4 × 10 15 cm −3 , respectivamente, devido à diminuição dramática do defeito nativo intrínseco de filmes finos de ZnO crescido com ALD.
Disponibilidade de dados e materiais
Os dados que suportam as conclusões deste estudo estão disponíveis com o autor correspondente (Yung-Chen Cheng) mediante solicitação razoável.
Abreviações
- ALD:
-
Deposição de camada atômica
- O 3 :
-
Ozônio
- TA:
-
Recozimento térmico
- O 2 :
-
Oxigênio
- PL:
-
Fotoluminescência
- H 2 O:
-
Água
- H 2 O 2 :
-
Peróxido de hidrogênio
- OH:
-
Hidroxila
- Zn i :
-
Intersticiais de zinco
- V O :
-
Vagas de oxigênio
- TDs:
-
Deslocamentos de rosca
- GBs:
-
Limites de grãos
- NBE:
-
Perto da borda do bandgap
- c-Al 2 O 3 :
-
safira c-face
- DI:
-
Deionizada
- C 2 H 5 :
-
Grupos etil
- N 2 :
-
Gás nitrogênio
- Zn:
-
Zinco
- XRD:
-
Difração de raios X
- AFM:
-
Microscópio de força atômica
- RMS:
-
Raiz quadrada média
Nanomateriais
- Tecnologias de Deposição de Camada Atômica Avançada para Micro-LEDs e VCSELs
- Características de chaveamento resistivo bipolar de dispositivos RRAM de estrutura tricamada de HfO2 / TiO2 / HfO2 em substratos revestidos com Pt e TiN fabricados por deposição de camada atômica
- Características interfaciais, elétricas e de alinhamento de banda de pilhas de HfO2 / Ge com camada intermediária de SiO2 formada in situ por deposição de camada atômica aprimorada com plasma
- As Nanofibras Hierárquicas de Poliamida 6-ZnO Antibacteriana Fabricadas por Deposição de Camada Atômica e Crescimento Hidrotérmico
- Propriedades fotocatalíticas de pós de TiO2 revestidos com Co3O4 preparados por deposição de camada atômica aprimorada com plasma
- Ajustando as morfologias de superfície e propriedades dos filmes ZnO pelo projeto da camada interfacial
- Ajuste de nível de Fermi de filmes ZnO por meio de deposição de camada atômica superciclada
- Estudo da Força de Adesão e Transição de Vidro de Filmes de Poliestireno Fino por Microscopia de Força Atômica
- Preparação e Características Termoelétricas de ITO / PtRh:Termopar de Filme Fino PtRh
- Um método conveniente e eficaz para depositar filme fino de baixa densidade nc-Si:H da PECVD



