Um estudo comparativo sobre o desempenho ferroelétrico em filmes finos Hf0.5Zr0.5O2 depositados em camada atômica usando precursores de Tetrakis (etilmetilamino) e Tetrakis (dimetilamino)
Resumo
As propriedades químicas, físicas e elétricas da camada atômica depositada Hf 0,5 Zr 0,5 O 2 filmes finos usando tetraquis (etilmetilamino) (TEMA) e precursores de tetraquis (dimetilamino) (TDMA) são comparados. O ligante dos precursores metal-orgânicos afeta fortemente a concentração residual de C, o tamanho do grão e as propriedades ferroelétricas resultantes. Depositando Hf 0,5 Zr 0,5 O 2 filmes com os precursores TDMA resultam em menor concentração de C e tamanho de grão ligeiramente maior. Essas descobertas são benéficas para o crescimento de mais filme de fase ferroelétrica dominante, o que atenua seu efeito de ativação. Do teste de despertar do TDMA-Hf 0,5 Zr 0,5 O 2 filme com um campo de ciclagem de 2,8 MV / cm, o efeito de despertar adverso foi bem suprimido até 10 5 ciclos, com um valor de polarização dupla remanente razoavelmente alto de ~ 40 μC / cm 2 . O filme também mostrou uma troca confiável de até 10 9 ciclos com o campo de ciclismo de 2,5 MV / cm sem envolver o efeito de despertar, mas com o comportamento típico de fadiga.
Introdução
Camada atômica depositada Hf 1- x Zr x O 2 (HZO, x ~ 0,5) filmes finos têm sido os principais candidatos como camada ferroelétrica ultrafina (FE) no campo de dispositivos semicondutores para aplicações lógicas e de memória. Isso ocorre porque o filme de estrutura de fluorita FE HZO pode ser reduzido até abaixo de 10 nm e depositado homogeneamente em nanoestruturas tridimensionais utilizando técnicas de deposição de camada atômica maturada (ALD). Além disso, é compatível com o eletrodo TiN convencional [1, 2], o que dificilmente pode ser obtido a partir dos ferroelétricos de estrutura perovskita convencionais. Apesar da melhoria significativa no processamento de filmes HZO e fabricação de dispositivos usando os filmes finos baseados em ALD nos últimos anos, existem várias deficiências não resolvidas. Especialmente, a confiabilidade dos ferroelétricos de estrutura de fluorita é incerta. Atualmente, o efeito de despertar e o número limitado de endurance são considerados os problemas mais graves [3]. Geralmente, as curvas do campo elétrico de polarização (P – E) são comprimidas no estado primitivo, sugerindo que o campo coercivo (E c ) é espacialmente não uniforme e vários domínios FE são fixados [4]. Após o ciclo de campo elétrico com uma intensidade de campo superior a E c , curvas P – E mais simétricas e quadradas podem ser obtidas, um fenômeno conhecido como efeito de despertar. Em alguns casos, esse processo de despertar dura 10 4 –10 5 ciclos, que é um ciclo de resistência típico de ca. memória flash, dificultando a operação do dispositivo e do sistema [5]. O número limitado de resistência é outro problema crítico se for para ser usado como memória de trabalho (resistência> 10 15 É necessário). Para estrutura de capacitor metal-ferroelétrico-metal, a resistência máxima relatada é inferior a 10 11 [6], e para a pilha de portas de metal ferroelétrico semicondutor em transistor de efeito de campo ferroelétrico, a resistência é limitada a 10 5 vezes [3, 7].
Várias origens do efeito de despertar foram sugeridas na literatura. Os mecanismos sugeridos são a fixação de limites de domínio por defeitos, como impurezas, vacâncias de oxigênio e presença da fase não ferroelétrica (fase cúbica ou tetragonal) nas interfaces adjacentes aos eletrodos ou canal semicondutor no estado original [5, 8 , 9,10]. Espera-se que a concentração do local de fixação diminua durante a comutação repetitiva da polarização. Além disso, o ciclo do campo elétrico transforma as fases interfaciais tetragonal ou cúbica na fase ortorrômbica FE [5]. Este estudo se concentrou principalmente em melhorar o desempenho elétrico do filme HZO ou eliminar o efeito de despertar, adotando precursores alternativos de Hf e Zr durante o processo ALD, o que pode resultar em uma concentração mais baixa de impurezas, especialmente impurezas de carbono.
Para os processos ALD usando os precursores orgânicos de metal, é quase inevitável induzir impurezas residuais, como C, N e H no filme crescido, que são provavelmente originadas dos ligantes orgânicos. Kim et al. [11, 12] mostraram que alterando a temperatura de deposição de HfO 2 e filme HZO, o polimorfismo e as propriedades elétricas resultantes podem ser controlados. A partir da espectroscopia de elétrons Auger (AES), a concentração de C no filme fino de ALD HZO aumentou com a diminuição da temperatura de deposição, o que pode resultar das reações de troca de ligante imperfeitas [11, 12]. Além disso, o diâmetro do grão lateral diminuiu com o aumento da concentração de C. A formação das fases instáveis ou metaestáveis (tetragonal, ortorrômbica e cúbica) em vez da fase monoclínica estável em tais filmes de estrutura de fluorita está intimamente relacionada com o efeito do tamanho do grão [13,14,15,16]. Assim, controlar a concentração de impurezas é crucial para atingir a fase desejada (FE ortorrômbica), bem como aumentar a confiabilidade elétrica do filme.
Para o ALD de FE HZO filmes finos, os precursores metal-orgânicos Hf e Zr mais frequentemente usados são o tetraquis [etilmetilamino] háfnio (TEMAH) e tetraquis [etilmetilamino] zircônio (TEMAZ) [11, 12, 17]. Esses precursores foram desenvolvidos para a deposição de vapor químico orgânico-metálico com o intuito de facilitar a decomposição do ligante por meio da transferência de carga elétrica entre os grupos metil e etil [18,19,20]. No entanto, este tipo de decomposição de ligante induzida termicamente e subsequente remoção dos (fragmentos de) ligantes orgânicos interfere adversamente com a reação ALD fácil, resultando na incorporação de impurezas (C, H e N) no filme [11, 17,18, 19,20].
Em contraste, os precursores tetraquis [dimetilamino] háfnio (TDMAH) e tetraquis [dimetilamino] zircônio (TDMAZ), que também foram usados para depositar os filmes FE HZO [21,22,23,24], têm apenas grupos metil em seus ligantes. Portanto, tal efeito adverso pode não ser sério, embora a supressão completa da decomposição térmica não possa ser garantida.
Este estudo realizou uma análise comparativa entre os filmes de HZO crescidos pelos processos ALD com dois diferentes precursores metálicos; TEMAH / TEMAZ e TDMAH / TDMAZ. O último processo resultou na menor concentração de C no filme, o que melhorou significativamente o desempenho elétrico do filme HZO. Sob as condições otimizadas do ciclo de comutação, quase nenhum efeito de despertar foi alcançado enquanto a polarização comutável permaneceu em ~ 40 μC / cm 2 .
Métodos / Experimental
Preparação do Hf 0,5 Zr 0,5 O 2 Filmes finos
Este trabalho examinou a influência dos tipos de precursores orgânicos de metal na estrutura e no desempenho elétrico da camada atômica Hf 0,5 depositada Zr 0,5 O 2 filmes finos. Os filmes finos de HZO foram depositados usando um reator ALD térmico de escala de 4 polegadas de diâmetro com TDMAH (ou TEMAH), TDMAZ (ou TEMAZ) e ozônio (190 g / m 3 concentração) como o precursor Hf, precursor Zr e fonte de oxigênio, respectivamente. O processo ALD otimizado com precursores TEMAH / TEMAZ foi como nos estudos anteriores dos autores [5, 9, 11,12,13,14,15,16]. Os filmes finos de HZO com precursores TDMAH / TDMAZ foram preparados por ALD térmico a uma temperatura de substrato de 260 ° C. A proporção Hf:Zr de 50:50 foi escolhida para o teste elétrico, uma vez que foi relatado que a composição mostra a maior polarização remanente (P r ) valor em estudos anteriores [17, 25, 26]. Os filmes finos de HZO com os precursores TDMAH / TDMAZ foram depositados com razão de ciclo ALD 1:1 dos precursores Hf e Zr em TiN / Ti / SiO 2 Substrato / Si. Um ciclo ALD era composto de alimentação da fonte (2 s) - purga da fonte (20 s) - alimentação do ozônio (3 s) - processo de purga do ozônio (10 s). A taxa de crescimento do filme de HZO foi de 0,13 nm por ciclo e os filmes finos de HZO de 10 nm de espessura foram preparados pelos precursores TDMAH / TDMAZ para os experimentos. As condições ideais podem variar dependendo do volume da câmara ALD. A Tabela 1 mostra a comparação das propriedades físicas das fontes TEMA e TDMA. Os filmes de TiN (50 nm) e Ti (5 nm) foram depositados usando pulverização catódica com um poder de pulverização catódica de 5 kW em substratos de Si tipo p termicamente oxidados usando uma ferramenta de pulverização catódica comercial (Endura, Applied Materials). Os filmes de HZO depositados são apenas parcialmente cristalinos ou amorfos no estado como depositado, então o recozimento subsequente para cristalização foi conduzido usando um processo térmico rápido (RTP) a 450 ° C em N 2 atmosfera.
Caracterização das propriedades químicas / físicas do Hf 0,5 Zr 0,5 O 2 Filmes finos
As estruturas cristalinas dos filmes depositados foram analisadas usando um difratômetro de raios-X (XRD, X’pert pro, Panalytical) dentro de uma geometria de incidência rasante com um ângulo de incidência de 0,5 °. As microestruturas das amostras foram analisadas em microscopia eletrônica de varredura (MEV, S-4800, Hitachi), e a distribuição granulométrica foi analisada em um software Gwyddion [29] por meio de um método de bacia hidrográfica. As composições químicas do filme de HZO depositado foram analisadas usando fluorescência de raios-X (XRF, Quant'X, Thermo SCIENTIFIC), e as variações profundas nas composições químicas, incluindo impurezas como C, foram analisadas usando um tempo de espectroscopia de elétrons Auger de voo (AES, PHI-700, ULVAC-PHI).
Caracterização das propriedades elétricas do Hf 0,5 Zr 0,5 O 2 Filmes finos
Para analisar as propriedades elétricas dos filmes de HZO, os eletrodos TiN superiores foram depositados reativamente por meio de um processo de pulverização catódica com uma potência de 100 W sob 92,6% -Ar / 7,4% -N 2 atmosfera. Os eletrodos de topo TiN foram padronizados usando uma máscara de sombra com orifícios circulares com um diâmetro de 300 μm. As características P – E foram analisadas usando um testador ferroelétrico (analisador TF 2000, sistemas Aixacct) a uma frequência de medição de 1 kHz. O teste de resistência foi realizado com pulsos bipolares retangulares com altura e largura de 2,8 ~ 3,8 MV / cm e 10 μs, respectivamente, gerados por um gerador de pulsos (81110A, Agilent) e um testador ferroelétrico (analisador TF 2000, sistemas Aixacct). As características de capacitância-tensão (C-V) foram medidas usando um analisador de impedância (4194A, Hewlett-Packard) sob os pulsos sinusoidais CA com uma frequência de 10 kHz e uma altura de 50 mV combinada com polarização CC. As constantes dielétricas dos filmes de HZO foram calculadas a partir da capacitância medida, bem como da área do eletrodo medida por microscopia óptica e espessura medida usando elipsometria espectroscópica (ESM-300, J. A. Woollam). As características do campo elétrico de densidade de corrente (J-E) foram analisadas usando um analisador de parâmetro de semicondutor (4155B, Hewlett-Packard) sob polarização DC com um tempo de retardo de 1 s.
Resultados e discussão
A Figura 1a mostra os padrões de difração de raios-X de incidência rasante (GIXRD) de Hf 0,5 de 10 nm de espessura Zr 0,5 O 2 filmes finos depositados usando TDMAH / TDMAZ (TDMA-HZO, curva preta) e TEMAH / TEMAZ (TEMA-HZO, curva vermelha) com um ângulo de incidência de 0,5 °. Os padrões de referência retirados da literatura para as fases monoclínica, tetragonal e ortorrômbica estão anexados na parte inferior. A partir de ambos os padrões GIXRD dos filmes TDMA e TEMA HZO, as intensidades dos picos de difração da fase monoclínica foram desprezíveis e nenhuma diferença notável nas formas e intensidades dos picos pôde ser identificada. Assim, nenhuma diferença significativa na estrutura cristalográfica entre TDMA e TEMA HZO foi confirmada experimentalmente a partir do GIXRD.

(a) Os padrões GIXRD de filmes finos de HZO depositados usando TDMAH / TDMAZ (curva preta) e TEMAH / TEMAZ (curva vermelha), os padrões de referência retirados da literatura para as fases monoclínica, tetragonal e ortorrômbica estão fixados nos painéis inferiores. ( b) A imagem SEM planar de filmes TDMA HZO e ( c) a distribuição de tamanho de grão de TEMA (vermelho; reproduzido da Ref. [15]), TDMA (preto) HZO. ( d) O perfil de profundidade dos filmes finos TDMA HZO analisados usando espectroscopia de elétrons Auger de tempo de voo, e ( e) a região ampliada de baixa concentração da parte do filme HZO. A concentração média de C de TDMA (linha tracejada preta), TEMA (linha tracejada vermelha; reproduzida da Ref. [12]), HZO é apresentada
A microestrutura, incluindo o tamanho do grão lateral, é outro fator crítico que pode afetar fortemente as propriedades FE de filmes finos de HZO [13,14,15,16, 30]. Assim, as microestruturas dos filmes TDMA e TEMA HZO foram analisadas por meio de microscopia eletrônica de varredura (MEV). A Figura 1b mostra a imagem SEM planar de filmes TDMA HZO. Vários estudos anteriores relataram que os filmes finos de HZO depositados usando ALD térmico mostraram estrutura de grão colunar, sugerindo que o tamanho do grão vertical é tão grande quanto a espessura do filme [1, 5, 11, 31]. A distribuição do tamanho de grão lateral analisada usando o software citado acima [29], foi ajustada com a função Gaussiana. A distribuição do tamanho do grão de TEMA HZO (curva vermelha) foi retirada de um estudo anterior [15] e plotada com a de TDMA HZO (curva preta) na Fig. 1c. Conforme mostrado na Fig. 1c, o diâmetro médio do grão lateral do TDMA HZO (8,5 nm) era maior do que o do TEMA HZO (7,1 nm). Esta pode ser a principal razão para o desempenho aprimorado de FE do TDMA HZO. De acordo com relatórios anteriores, a formação das fases metaestáveis, como as fases ortorrômbica e tetragonal, é impulsionada pelas origens cinéticas, e as fases tetragonal e ortorrômbica são preferidas na região de tamanho de grão pequeno [13, 16]. Grãos muito maiores preferem fases monoclínicas, grãos menores preferem a fase tetragonal e grãos ligeiramente maiores preferem a fase ortorrômbica. A quase sobreposição das posições de pico das duas fases (fases tetragonal e ortorrômbica) nos padrões de difração não permitiu a identificação inequívoca da fase principal nos dois filmes. No entanto, o SEM e a análise de tamanho de grão acompanhante indicaram que o filme TDMA HZO poderia ter uma porção maior da fase ortorrômbica em comparação com o filme TEMA HZO.
Os diferentes tamanhos de grão podem ser originados como resultado dos diferentes níveis de concentração de impureza C nos dois filmes. As concentrações de impurezas podem afetar fortemente a microestrutura e as propriedades ferroelétricas resultantes de filmes finos de HZO [11, 12, 32]. Portanto, a composição química dos filmes finos de TDMA e TEMA HZO foi analisada usando tempo de voo AES e as concentrações profundas resultantes de vários átomos, como Hf, Zr, O, C, Ti e N em TDMA HZO filme foram plotados em função do tempo de pulverização catódica na Fig. 1d. A Figura 1e mostra a região ampliada de baixa concentração da Fig. 1d (caixa tracejada vermelha) na parte do filme HZO. A concentração média de C no filme TDMA HZO (quadrado preto) foi de ~ 2,4%, que é ~ 38% menor do que (~ 3,9%) do filme TEMA HZO (triângulo vermelho) [12], dos quais dados AES foram relatados no estudo anterior dos autores [12]. Todas as outras concentrações, incluindo N, não mostraram diferenças notáveis.
Cho et al. sugeriu que as impurezas residuais C formadas durante o processo ALD retardaram o crescimento do grão e resultou no pequeno tamanho de grão dos filmes finalmente depositados [32]. Uma tendência semelhante foi observada para Hf ferroelétrico 0,5 Zr 0,5 O 2 filmes finos e HfO puro 2 filmes de Kim et al. quando a temperatura de deposição diminuiu de 280 para 200 ° C [11, 12]. Jung et al. usaram simulações computacionais para mostrar que a diferença de energia livre entre a fase tetragonal e monoclínica diminui com o aumento da concentração de C em HfO 2 , sugerindo que a inclusão de impureza C aumenta a estabilidade da fase tetragonal metaestável [33]. Kuenneth et al. também examinou o efeito da concentração de C nos valores de energia livre de HfO 2 . Porém, relataram que o aumento da concentração de C não resultou na diminuição da diferença de energia livre entre a fase ortorrômbica e a fase monoclínica [34]. No trabalho de Kuenneth et al., Os defeitos substitucionais C foram considerados, embora as impurezas C sejam geralmente conhecidas como defeitos intersticiais em HfO 2 [33, 35]. Portanto, os cálculos teóricos não revelaram claramente que as impurezas C poderiam diminuir a diferença de energia livre entre as fases tetragonal e ortorrômbica. No entanto, experimentos confirmaram que o aumento de impurezas C poderia aumentar a fração de fase tetragonal nos filmes finos de ALD HZO [11, 12, 33].
A concentração mais baixa de impureza C no filme TDMA HZO pode ser atribuída à natureza de decomposição térmica diferente dos ligantes TDMA e TEMA. Os átomos de carbono mais externos nos ligantes TEMA são propensos a serem dissociados termicamente e permaneceram na superfície do filme durante o processo ALD [11, 12], o que pode não ser o caso no ligante TDMA.
Na próxima etapa, o efeito da concentração de C e a microestrutura resultante nas propriedades ferroelétricas são discutidos. As Figuras 2a eb mostram as curvas P – E de capacitores MFM com os filmes TDMA HZO e TEMA HZO, respectivamente, medidos em um estado primitivo e estados fatigados comutados por 10 2 , 10 3 , 10 4 e 10 5 vezes usando os pulsos retangulares bipolares de 3,8 MV / cm de altura e 10 μs de largura. A partir das curvas P – E nas Fig. 2a eb (estado original), a curva P – E do capacitor TEMA HZO (curva preta, Fig. 2b) é mais fortemente comprimida no estado puro em comparação com o capacitor TDMA HZO (preto curva, Fig. 2a). A Figura 2b mostra claramente as saliências na curva P – E primitiva do capacitor TEMA HZO, o que não é o caso para a curva P – E primitiva do capacitor TDMA HZO. As saliências na curva P – E se originam da divisão dos picos de corrente de comutação, que geralmente resulta da não homogeneidade espacial no campo elétrico interno e / ou campo coercitivo. A Figura 2c mostra as mudanças em 2P r valores dos capacitores TDMA e TEMA HZO em função dos pulsos de fadiga. O 2P r valores após 10 5 tempos de pulsos elétricos, em comparação com o primitivo 2P r valores, de capacitores TDMA e TEMA HZO são ~ 80 e ~ 69%, respectivamente. Isso sugere que o filme TEMA HZO tem um comportamento de despertar superior em comparação com o filme TDMA HZO.

As curvas de polarização-campo elétrico (P – E) de ( a ) o TDMA HZO e ( b ) TEMA HZO (reproduzido da Ref. [5]) capacitores medidos no estado original e fatigado pulsados por 10 2 , 10 3 , 10 4 e 10 5 vezes a pulsos retangulares bipolares de 3,8 MV / cm de altura e 10 μs de largura. ( c) As mudanças em 2P r valores dos capacitores HZO TDMA (preto) e TEMA (vermelho) em função dos pulsos de fadiga. A constante dielétrica - curvas de campo elétrico de ( d ) o TDMA HZO e ( e ) Capacitores TEMA HZO (reproduzido da Ref. [5]) com os eletrodos TiN superior e inferior medidos no estado puro e fatigado. ( f) As mudanças nos valores da constante dielétrica com o aumento do número de pulsos de fadiga para capacitores HZO TDMA (preto) e TEMA (vermelho)
As Figuras 2d ee mostram a constante dielétrica-campo elétrico (ε r - E) curvas dos capacitores TDMA HZO e TEMA HZO medidos em um estado primitivo e estados fatigados comutados por 10 2 , 10 3 , 10 4 e 10 5 vezes usando os pulsos retangulares bipolares de 3,8 MV / cm de altura e 10 μs de largura. O ε r os valores do capacitor TDMA HZO são significativamente menores do que os dos capacitores TEMA HZO em todas as condições de teste. A Figura 2f mostra as mudanças em ε r valores com o número crescente de ciclos de chaveamento de fadiga para capacitores TDMA e TEMA HZO. O ε r os valores foram calculados pela média ε r valores medidos nos campos elétricos mais altos e mais baixos nas Fig. 2d e e. A partir dos padrões GIXRD na Fig. 1a, as frações de fase monoclínica em ambos os filmes foram desprezíveis. Assim, a diferença em ε r o valor pode ser determinado pelas frações relativas das fases tetragonal e ortorrômbica ou pela concentração do defeito, que se espera diminuir a constante dielétrica média com distorções locais da rede. O ε r o valor da fase tetragonal (35–40) foi superior ao da fase ortorrômbica (25–30). Assim, o alto ε r O valor do capacitor TEMA HZO indica que ele tem uma fração de fase tetragonal mais alta em comparação com os capacitores TDMA HZO. Com o aumento do número de pulsos de fadiga, o ε r valor de ambos os capacitores TEMA HZO e TDMA HZO diminui, como mostrado na Fig. 2f. A magnitude da diminuição em ε r valor durante 10 5 A comutação de polarização de vezes para o capacitor TDMA HZO (26,8 a 25,3) foi menor do que para o capacitor TEMA-HZO (32,2 a 29,6) em ~ 42%. Isso é consistente com o comportamento de despertar mostrado na Fig. 2c.
A diferença na fração de fase tetragonal e os diferentes ε r resultantes o valor dos filmes finos de TDMA e TEMA HZO pode ser entendido a partir da diferença na concentração de C. De acordo com Kim et al. [12], o aumento da concentração de C diminui a energia livre da fase tetragonal em relação à fase ortorrômbica (a fase tetragonal é ainda mais favorável em comparação com a fase ortorrômbica). Como resultado, com o aumento da concentração de C, espera-se que a fração da fase tetragonal aumente. Como a concentração de C do filme TDMA HZO é menor do que a do filme TEMA HZO, espera-se que a fração da fase tetragonal no filme TDMA HZO seja menor do que a do filme TEMA HZO. A diferença no tamanho do grão mostrado na Fig. 1c também apóia a mesma tendência nas frações de fase cristalina relativas. De acordo com Materlik et al. [30], a energia de superfície livre da fase tetragonal (2,5 J / m 2 ) é menor do que (2,9 J / m 2 ) da fase ortorrômbica, embora essas energias de superfície livre tenham sido estimadas para explicar as observações experimentais em filmes finos de HZO com várias espessuras e concentrações de Zr. Batra et al. [36] calcularam a energia da superfície livre das várias fases cristalinas com várias orientações e mostraram que a energia da superfície livre da fase tetragonal é menor do que a das fases ortorrômbica e monoclínica. É geralmente aceito que a energia de contorno de grão de alto ângulo é aproximadamente 1/3 da energia da superfície livre [37]. Assim, a energia de contorno do grão da fase tetragonal é a mais baixa em comparação com as fases ortorrômbica e monoclínica, tornando-a a fase mais estável no menor tamanho de grão. Estes são consistentes com a ideia de que o menor tamanho de grão do TEMA HZO tende a incluir uma porção maior da fase tetragonal não ferroelétrica em comparação com o filme TDMA HZO, que teve um maior tamanho de grão médio. Portanto, a concentração de C experimentalmente observada e o tamanho de grão suportam consistentemente a estrutura cristalina diferente e as propriedades elétricas resultantes dos filmes finos TDMA e TEMA HZO.
Para elucidar o mecanismo por trás do efeito de despertar, a medição de comutação de pulso, que pode estimar a capacitância interfacial (C i ) proveniente da camada não ferroelétrica próxima aos eletrodos, foi conduzido em capacitores TDMA HZO e TEMA HZO [5]. As Figuras 3a eb mostram as mudanças em C i , resistência de contato (R c ), e E c valores com o aumento do número de pulsos de fadiga para os capacitores TDMA HZO e TEMA HZO, respectivamente. O método de medição detalhado e os resultados estão incluídos nas informações de suporte online. Os dados para o capacitor TEMA HZO foram retirados do trabalho anterior de Kim et al. [5], onde o C i o valor aumenta com o aumento do número de ciclos de campo elétrico [5]. No estado original, o C i (37,6 μF / cm 2 ) o valor do capacitor TDMA é maior do que (21,1 μF / cm 2 ) do capacitor TEMA HZO em ~ 75%, sugerindo que a espessura da camada interfacial não ferroelétrica em TDMA HZO é muito menor do que no filme TEMA HZO. Por outro lado, a diferença em E c valor no estado primitivo dos capacitores TDMA e TEMA HZO é de apenas 13%, sugerindo que a principal razão para a diferença nas características P – E primitivas dos capacitores TDMA e TEMA HZO é a espessura diferente das camadas interfaciais não ferroelétricas. Desde R c valor é fortemente afetado pela resistência de contato para a configuração do teste elétrico, pode ter menor importância em comparação com os outros dois fatores. Portanto, as diferentes características P – E no estado primitivo do capacitor TDMA e TEMA HZO podem ser compreendidas de forma consistente com base no modelo de despertar anterior sugerido por Kim et al. [5]. De acordo com os estudos anteriores, a concentração de vacância de oxigênio perto dos eletrodos TiN é maior do que a região da massa do filme no estado original. De acordo com Hoffmann et al. [38], o aumento da concentração de vacância de oxigênio aumenta a estabilidade da fase tetragonal em comparação com a fase ortorrômbica. Durante a alternância de polarização repetitiva no teste de resistência, a fase tetragonal interfacial parecia se converter para a fase ortorrômbica FE, difundindo as lacunas de oxigênio na região do filme. O campo aplicado também induziu a transição de fase da fase interfacial não-FE para a fase FE. Como a espessura da camada interfacial do capacitor TDMA-HZO é menor do que a dos capacitores TEMA-HZO no estado puro, o efeito de despertar durante o ciclo de campo pode ser mitigado.
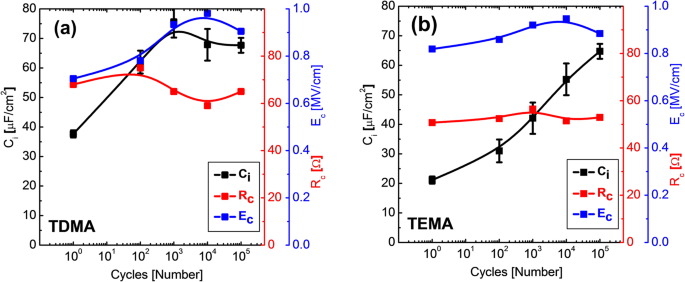
As mudanças de ( a ) TDMA HZO e ( b ) TEMA HZO (reproduzido da Ref. [5]) em capacitância interfacial (C i ), resistência de contato (R c ), e campo coercitivo (E c ) valores com o aumento do número de pulsos de fadiga
Além disso, a amplitude do pulso de fadiga é outro fator crucial que pode afetar fortemente os fenômenos de despertar dos ferroelétricos de estrutura de fluorita [6, 8]. Portanto, o efeito de despertar do capacitor TDMA HZO foi examinado usando pulsos de fadiga com várias amplitudes de 2,8, 3,1, 3,5 e 3,8 MV / cm. As Figuras 4a, be c mostram as curvas P – E medidas durante o teste de despertar com alturas de pulso de fadiga de 2,8, 3,1 e 3,5 MV / cm, respectivamente. As mudanças em 2P r durante o teste de despertar foram resumidos na Fig. 4d. Semelhante ao resultado do teste de despertar mostrado na Fig. 2a, a medição P – E foi realizada no campo elétrico de medição de 3,8 MV / cm, após um determinado número de ciclos de despertar com a amplitude de campo dada. As mudanças na histerese P – E diminuem com a diminuição da amplitude dos pulsos de fadiga, conforme mostrado na Fig. 4a – c. A Figura 4d mostra um resumo das mudanças em 2P r valor durante o teste de resistência com pulsos de fadiga de amplitude de 2,8, 3,1, 3,5 e 3,8 MV / cm. Como visto na Fig. 4d, a magnitude de 2P r aumentar após 10 5 tempos de ciclagem de campo foram 0,41, 5,18, 9,93 e 9,94 μC / cm 2 para as diferentes amplitudes de campo de fadiga, que correspondem a variações de ~ 1, ~ 13, ~ 26 e ~ 24%, respectivamente. Este resultado implica que o efeito de despertar é desprezível quando um pulso de fadiga de amplitude de 2,8 MV / cm foi aplicado, onde um 2P r razoavelmente alto valor (~ 40 μC / cm 2 ) ainda poderia ser alcançado.
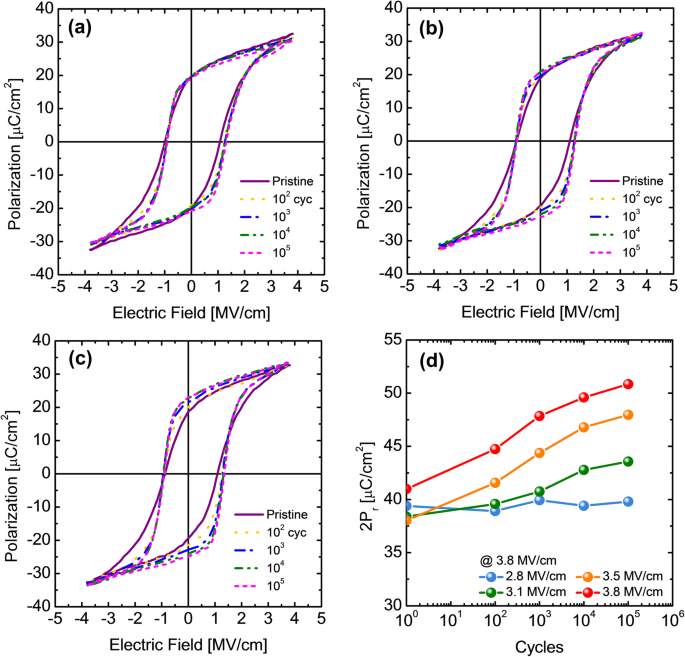
As curvas do campo elétrico de polarização (P – E) medidas durante o teste de despertar com a altura do pulso de fadiga de ( a ) 2.8, ( b ) 3.1, e ( c ) 3,5 MV / cm. ( d) As mudanças em 2P r valor durante o teste de resistência com pulsos de fadiga de 2,8, 3,1, 3,5 e 3,8 MV / cm de altura
O efeito wake-up está fortemente relacionado com a deriva das vacâncias de oxigênio e a transição de fase resultante da fase tetragonal para a fase ortorrômbica, principalmente na camada interfacial [9, 10]. O desvio das vacâncias de oxigênio deve ser fortemente influenciado pela amplitude dos pulsos de fadiga, e a amplitude do campo de teste de fadiga apropriadamente mais baixa (2,8 MV / cm neste caso) pode mitigar amplamente esse efeito adverso. Embora o máximo atingível 2P r o valor diminuiu de ~ 51 μC / cm 2 (a 3,8 MV / cm) a ~ 40 μC / cm 2 (a 2,8 MV / cm), ~ 40 μC / cm 2 ainda é um valor razoavelmente alto para dispositivos de memória ferroelétricos. Para o caso do filme TEMA HZO, uma estratégia semelhante poderia ser aplicada para mitigar o problema de despertar, mas é inicialmente 2P r baixo valor (~ 30 μC / cm 2 ) pode ser o problema potencial para tal método.
A influência da concentração de C foi ainda mais esclarecida pelo teste de resistência até 10 9 ciclos, como mostrado nas Fig. 5a eb, que mostraram as variações em P r sob amplitude de campo de 2,5 e 3,0 MV / cm para os filmes TEMA e TDMA HZO, respectivamente. Em ambos os casos, o P r os valores foram estimados pelos loops P – E com o campo elétrico máximo de intensidade idêntica ao campo de ciclagem, então o P r estimado os valores são geralmente menores do que os valores da Fig. 4, onde os testes P – E foram realizados com 3,8 MV / cm. Quando o campo máximo (3,8 MV / cm) para o teste P – E na Fig. 4 foi utilizado para os testes de resistência, os filmes foram quebrados precocemente, proibindo os testes de resistência até os números de ciclo máximo. Os dois filmes mostraram tendências consistentes na evolução do P r vs. comportamento do ciclo:o filme TEMA HZO continuou aumentando o P r values, whereas the trend was much lower for the case of the TDMA HZO film. The TEMA HZO film showed unsteady Pr changes before break down at ~ 10 7 and ~ 10 9 cycles using 3.0 and 2.5 MV/cm field cycling, respectively. In contrast, the TDMA HZO film showed no indication of breakdown up to ~ 10 7 and ~ 10 9 cycles at 3.0 MV/cm and 2.5 MV/cm field cycling, and sudden breakdown was observed. The Pr value decreased slightly after ~ 10 7 under the cycling field strength of 2.5 MV/cm, which corresponds to the genuine fatigue behavior. Similar decay in the Pr performance with the switching cycles has been extensively reported for conventional perovskite ferroelectrics, which usually ascribed to the domain wall pinning by the increasing defect density [40, 41]. In the previous studies on the HZO-based ferroelectric thin films, such genuine fatigue behaviors have hardly been observed due to the involvement of significant wake-up and early breakdown, which was also the case in Fig. 5a. The data shown in Fig. 5b reveals that the HZO film may also suffer from the fatigue effect, known in the perovskite ferroelectric film, under the condition that the wake-up and early breakdown are appropriately addressed.
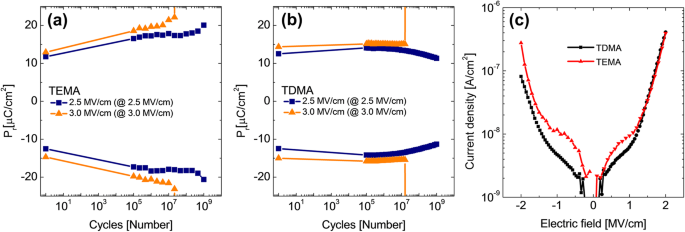
The results of endurance test of (a ) TEMA HZO (reproduced from Ref. 39) and (b ) TDMA HZO with the electric field cycling and pulse field amplitude of 2.5 and 3.0 MV/cm. The frequency of the rectangular double pulse for the endurance test was fixed at 100 kHz. (c) The current density–electric field curves of TDMA HZO (black) and TEMA HZO (red; reproduced from Ref. [39])
Figure 5c shows the comparison in the leakage current density performance of the two types of films. Due to the lower C concentration, TDMA HZO film had a lower leakage current than that of the TEMA HZO film at field strength <~ 1.5 MV/cm, where the trap-assisted tunneling may dominate. As a result of the leakage current improvement in TDMA HZO, the film did not show the breakdown up to 10 9 cycles, with relatively low field strength of 2.5 MV/cm.
However, in the higher field strength region, the difference becomes diminished, which may indicate that the high-field leakage current is more dominated by the interface Schottky barrier property, and such barrier property was less sensitive to the C concentration. Further research will be performed to more precisely identify the leakage current mechanism in subsequent work. The similar leakage currents in the high field region coincide with the no significant difference in the number of switching cycles before the breakdown at 3.0 MV/cm, shown in Fig. 5a and b.
Conclusão
In conclusion, this work examined the influence of types of metal-organic precursors on the structure and electrical performances of the atomic layer-deposited Hf0.5 Zr0.5 O 2 thin films. The adopted Hf and Zr precursors have either TEMA or TDMA ligands, where the former is more prone to the thermal decomposition compared to the latter. The ALD process using the precursors with TDMA ligands resulted in a lower C impurity concentration (~2.4 atomic % vs. ~3.9 atomic %) in the HZO film, which induced a slightly larger grain size (~8.5 nm vs. ~7.1 nm). As the slightly larger grain size prefers to have the ferroelectric orthorhombic phase rather than the non-ferroelectric tetragonal phase, the TDMA HZO film outperformed the TEMA HZO film, especially for the wake-up performance. When the wake-up field cycle was 2.8 MV/cm, the TDMA HZO film showed almost no wake-up effect, while a high 2Pr value of ~40 μC/cm 2 could be achieved. This is significant merit over the severely waking-up property of the TEMA HZO film. The TDMA HZO film also contained a lower portion of the interfacial non-ferroelectric phase with the TiN electrodes, compared with the TEMA HZO film. Due to the lower C concentration, the TDMA HZO film showed a lower leakage current in the low field region (<~1.5 MV/cm), but the high-field leakage current behaviors were similar. As a result, the number of switching cycles before breakdown was similar when the cycling field was as high as 3.0 MV/cm (~10 7 cycles), but it could be extended over 10 9 cycles when the cycling field was lower (2.5 MV/cm) for the case of the TDMA HZO film. The TDMA HZO film revealed that the typical fatigue behavior, i.e., decreasing Pr value with the increasing switching cycles, could be observed after ~ 10 7 cycles at 2.5 MV/cm, which might be ascribed to the domain wall pinning by the accumulated defects, as for the conventional perovskite ferroelectric films.
Disponibilidade de dados e materiais
The datasets supporting the conclusions of this article are included within the article and its Additional file 1.
Abreviações
- TEMA:
-
Tetrakis(ethylmethylamino)
- TDMA:
-
Tetrakis(dimethylamino)
- TEMAH:
-
Tetrakis[ethylmethylamino]hafnium
- TEMAZ:
-
Tetrakis[ethylmethylamino]zirconium
- TDMAH:
-
Tetrakis[dimethylamino]hafnium
- TEMAZ:
-
Tetrakis[dimethylamino]zirconium
- TDMA HZO:
-
Hf0.5 Zr0.5 O 2 thin films deposited using TDMAH/TDMAZ
- TEMA HZO:
-
Hf0.5 Zr0.5 O 2 thin films deposited using TEMAH/TEMAZ
- ALD:
-
Deposição de camada atômica
- AES:
-
Auger electron spectroscopy
- RTP:
-
Rapid thermal process
- XRD:
-
Difratômetro de raios x
- GIXRD:
-
Grazing incidence X-ray diffraction
- SEM:
-
Microscopia eletrônica de varredura
- HZO:
-
Hf1-x Zrx O 2 , x~0.5
- FE:
-
Ferroelétrico
- Pr :
-
Polarização remanescente
- Ec :
-
Coercive field
- P–E:
-
Polarization–electric field
- C–V:
-
Capacitance–voltage
- J–E:
-
Current density–electric field
- Ci :
-
Interfacial capacitance
- Rc :
-
Contact resistance
Nanomateriais
- Revelando a estrutura atômica e eletrônica das nanofibras de carbono de copo empilhado
- As Nanofibras Hierárquicas de Poliamida 6-ZnO Antibacteriana Fabricadas por Deposição de Camada Atômica e Crescimento Hidrotérmico
- Estudo de primeiros princípios sobre a estabilidade e imagem STM de Borophene
- Ajustando as morfologias de superfície e propriedades dos filmes ZnO pelo projeto da camada interfacial
- Fabricação de filmes finos SrGe2 em substratos Ge (100), (110) e (111)
- Estudo da Força de Adesão e Transição de Vidro de Filmes de Poliestireno Fino por Microscopia de Força Atômica
- Um estudo de nanofibras de carbono e carbono ativo como supercapacitor simétrico em eletrólito aquoso:um estudo comparativo
- Preparação e Características Termoelétricas de ITO / PtRh:Termopar de Filme Fino PtRh
- Estudos de TEM e STEM nas morfologias transversais de filmes anti-reflexo de SiO2 de banda larga dupla / tripla
- Estudo comparativo das propriedades eletroquímicas, biomédicas e térmicas de nanomateriais naturais e sintéticos



